
分析测试百科网 认证会员,请放心拨打!
赋能创“芯” | 半导体材料痕量杂质固体进样检测解决方案

目前,IC芯片的线宽分辨率已达到7nm以下的水平,制程中引入的极低含量的杂质污染或极小尺寸的颗粒污染都有可能产生严重的破坏性影响,导致芯片功能缺陷。因此,芯片制程的进展对于工艺和材料都提出了越来越高的要求。金属离子含量不超过10 ppb的高纯材料已经成为常态,今后对于金属离子的含量要求会转向ppb级甚至ppt级。
Element GD Plus辉光放电质谱仪自问世以来,在半导体材料检测领域发挥了wu ke替代的作用。在高纯材料检测中,为了实现高纯材料中痕量杂质的低检出限检测,选择合适的分辨率检测不同的杂质元素,同时尽可能降低质谱干扰的浓度无疑是非常必要的。Element GD Plus采用固体样品直接进样技术,具有背景低,基体效应小等突出优势,同时该设备还具有极低的质谱干扰浓度,和多种分辨率的灵活选择及自动软件控制模式,以上这些特点无疑是高纯材料检测的bi备条件。此外,Element GD Plus还具有突出的测样效率,可在15分钟内完成样品的全元素检测。

△Element GD Plus辉光放电质谱仪

半导体晶圆材料发展到现在,已经经历了三代,从最开始的锗,硅为代表的第一代到磷化铟,砷化镓等为代表的第二代,再到最近的碳化硅,氮化镓为代表的第三代半导体。其中应用最为广泛的当属高纯硅晶圆和高纯碳化硅晶圆。
采用辉光放电质谱法(GDMS)对高纯硅基材料进行痕量杂质分析的难点在于K,P,As,Se,Br,Cr,Fe,Ni,Zn等不同程度的受到ArH,SiH,SiSi,SiAr等的干扰。借助于Element GD Plus自身的设备优势,该设备可以轻松解决以上测试难点,实现硅基材料中痕量杂质的超低检出限检测。

△Element GD Plus在高纯硅检测中
可实现的杂质元素检出限
(点击查看大图)

溅射靶材是半导体制程中非常关键的材料,无论是前段制程中的二极管结构构建还是中后段制程中的线路互联,溅射靶材都是bi备材料。溅射靶材中痕量杂质的低检出限分析无疑是非常必要的。Element GD Plus由于其自身的优势,可轻松胜任各种高纯溅射靶材的高效检测。如常见的铜,钛,钽,钼,铝等高纯溅射靶材。
高纯铜靶材分析
辉光放电质谱法(GDMS)是进行高纯铜中痕量杂质元素含量的标准方法。YS/T 922-2013规定的73种痕量杂质元素中,K Zn Ge As Se Br Ru Rh等均存在基体相关的质谱干扰,是高纯铜分析的难点。以Rh为例说明Element GD Plus在高纯材料检测中的优势。

△Element GD Plus高分辨模式(分辨率为10000)下103Rh与CuAr分离情况(点击查看大图)
从上图中可以清楚的看出,元素103Rh在检测过程中受到63Cu40Ar的强质谱干扰,Element GD Plus借助其自身特点,zui大程度的减弱干扰信号强度,同时提供足够高的高分辨模式,成功将检测信号与干扰信号进行分离。

△采用Element GD Plus进行高纯铜检测
的全元素数据(点击查看大图)
从上图的实际数据中可以看出Element GD Plus在常规操作下的检测能力。根据实际需求,可以调节参数设置,以实现更低检出限的痕量杂质检测,可达0.01ppb甚至更低。
高纯铝靶材分析
采用辉光放电质谱法(GDMS)检测高纯材料时,不可避免的会采用一定的物理手段对样品进行处理,中间不可避免的会引入表面污染。尤其对于高纯铝这类硬度比较低的材料,样品处理过程引入的表面污染的深度会远大于其它材质。
遇到此类情形的常规操作是采用适当的化学试剂进行酸洗样品,以去除表面污染。Element GD Plus具备足够高的溅射功率,在测试样品未经化学处理的情况下,可在较短时间内完成表面污染的去除,从高纯铝样品进入设备到完成全元素检测,整个过程可在20分钟内完成。

△Element GD Plus在中分辨模式下同位素56Fe与干扰离子的分离情况(点击查看大图)

△采用Element GD Plus测试Alcan 112-03时的测试数值与标样数值的对比(点击查看大图)
高纯钼靶材分析
钼常见的稳定同位素有7个,这意味着在质谱检测过程中杂质元素受到质谱干扰影响的几率要远高于其它基体的检测,这无疑对于检测设备提出了严苛的要求。Element GD Plus鉴于其自身特点,可完全胜任高纯钼的检测,无论是控制质谱干扰的浓度,还是提供足够高的分辨率区分质谱干扰,表现都非常出色。同时Element GD Plus可以保证高效样品分析,15分钟可完成从进样到完成检测的分析过程。
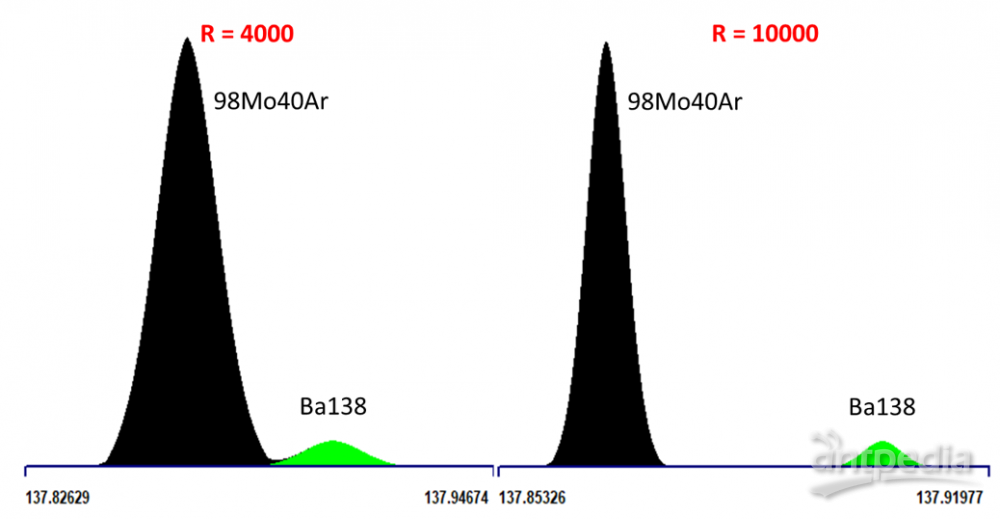
△138Ba同位素在不同分辨率模式下(左:中分辨;右:高分辨)与干扰信号98Mo40Ar的分离情况
(点击查看大图)
有色标准YST 1473-2021高纯钼化学分析方法中规定了高纯钼检测中,不同杂质检测所需的分辨率。

△YST 1473-2021中规定高纯钼检测中,不同杂质元素检测所需的分辨率(点击查看大图)

△采用Element GD Plus检测高纯钼样品的实际测试数据(点击查看大图)

高纯石墨在半导体制程及工艺中有举足轻重的作用。高纯石墨粉是合成高纯碳化硅的bi备原料;高温制程工艺中,高纯石墨件可以作为隔热材料,坩埚容器,干法刻蚀和MOCVD工艺中的核心元件以及晶体生长过程中的电极材料等。
采用辉光放电质谱法检测高纯石墨样品的难点在于,灵敏度低,不容易实现低检出限。而且该类样品极易收到污染,污染不能快速有效去除的结果就是样品无法成功进行测试。Element GD Plus具有溅射功率高,灵敏度高的先天优势,可以完全克服以上测试难点。

△Element GD Plus常规操作中可实现高纯石墨样品中杂质元素的检出限(点击查看大图)
用户可根据自身需求,调节测试参数,可进一步降低杂质元素检出限,提高痕量杂质的检测水平,杂质元素的检出限可达0.1ppb及以下。同时,Element GD Plus在高纯石墨样品的检测中同样具有高效的突出优势,可20分钟内完成高纯石墨样品的全元素检测。
相关会议推荐
7月20日,由中国计量科学研究院研究室主任 周涛老师带来《辉光放电质谱在高纯材料纯度分析中的应用》的主题演讲。
“半导体制造材料的检测分析与应用线上研讨会”完整日程如下。



| 标签: | 辉光放电质谱仪 |


