
金鉴检测双束FIB提供TEM制样、FIB切割、Pt沉积和三维重构的服务
聚焦离子束(FIB)与扫描电子显微镜(SEM)耦合成为FIB-SEM双束系统后,通过结合相应的气体沉积装置,纳米操纵仪,各种探测器及可控的样品台等附件成为一个集微区成像、加工、分析、操纵于一体的分析仪器。其应用范围也已经从半导体行业拓展至材料科学、生命科学和地质学等众多领域。为方便客户对材料进行深入的失效分析及研究,金鉴检测现推出Dual Beam FIB-SEM制样业务,并介绍Dual Beam FIB-SEM在材料科学领域的一些典型应用,包括透射电镜( TEM)样品制备,材料微观截面截取与观察、样品微观刻蚀与沉积以及材料三维成像及分析。
1. 设备参数
ZEISS Auriga Compact
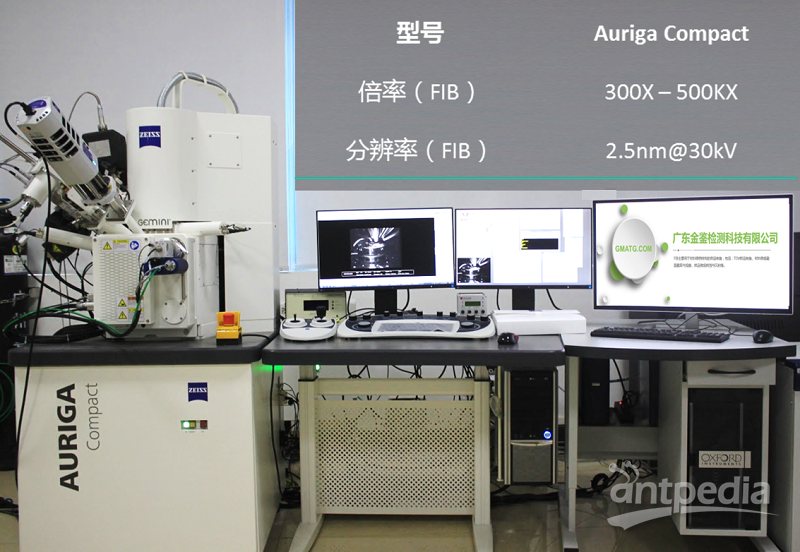
1.场发射扫描电镜(SEM):各种材料形貌观察和分析,如金属、半导体、陶瓷、高分子材料、有机聚合物等,放大率:12×~1000,000×;分辨率1.0nm @ 15kV;1.9 nm @ 1kV;
2.X射线能谱分析仪(EDS):材料微区成分分析;MnKa峰的半高宽优于127eV;CKa峰的版高宽优于56Ev;FKa峰的半高宽优于64eV;元素Be4-U92;
3.聚焦离子束系统(FIB):材料微纳结构的样品制备,包括:SEM在线观察下制备TEM样品、材料微观截面截取与观察、样品微观刻蚀与沉积等,放大率:300×~500,000×;分辨率2.5nm @ 30kV。
4.背散射电子探头(BSD):基于不同元素衬度不同,BSD探头除了观察样品形貌衬度,同时能够实现对样品成分衬度的观察。
5.纳米操纵手:用于超薄样品(纳米级)固定转移及精细加工。
6.气相沉积系统(GIS):FIB加工前为材料提供保护层,或用于材料精加工。
Dual Beam FIB-SEM制样:
FIB主要用于材料微纳结构的样品制备,包括:TEM样品制备、材料微观截面截取与观察、样品微观刻蚀与沉积等。

1.TEM样品制备
对比与传统的电解双喷,离子减薄方式制备TEM样品,FIB可实现快速定点制样,获得高质量TEM样品。
案例一:
使用Dual Beam FIB-SEM系统制备高质量TEM样品。
a、FIB粗加工
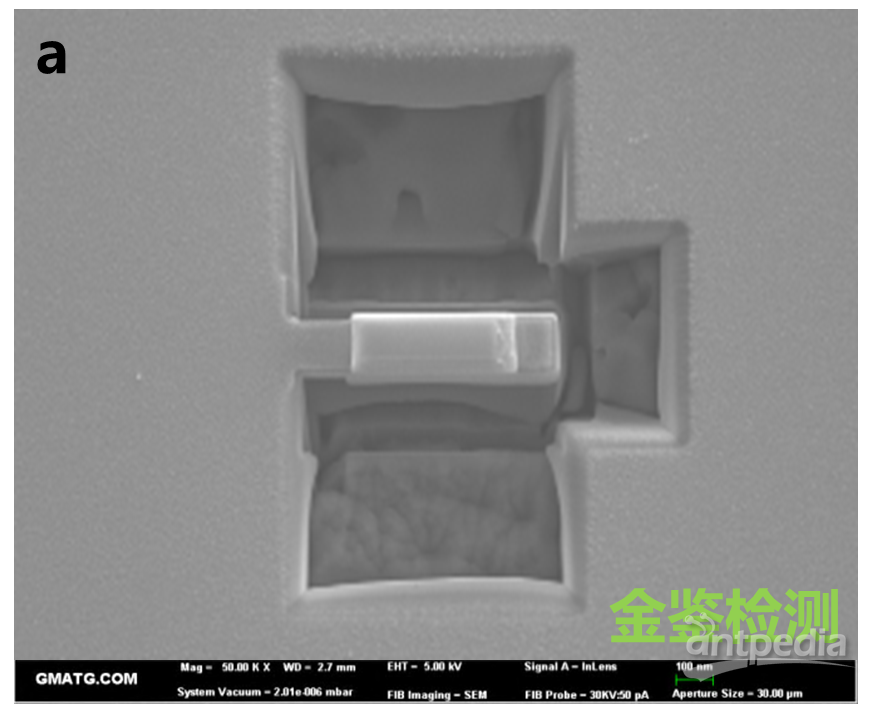
b、纳米手转移
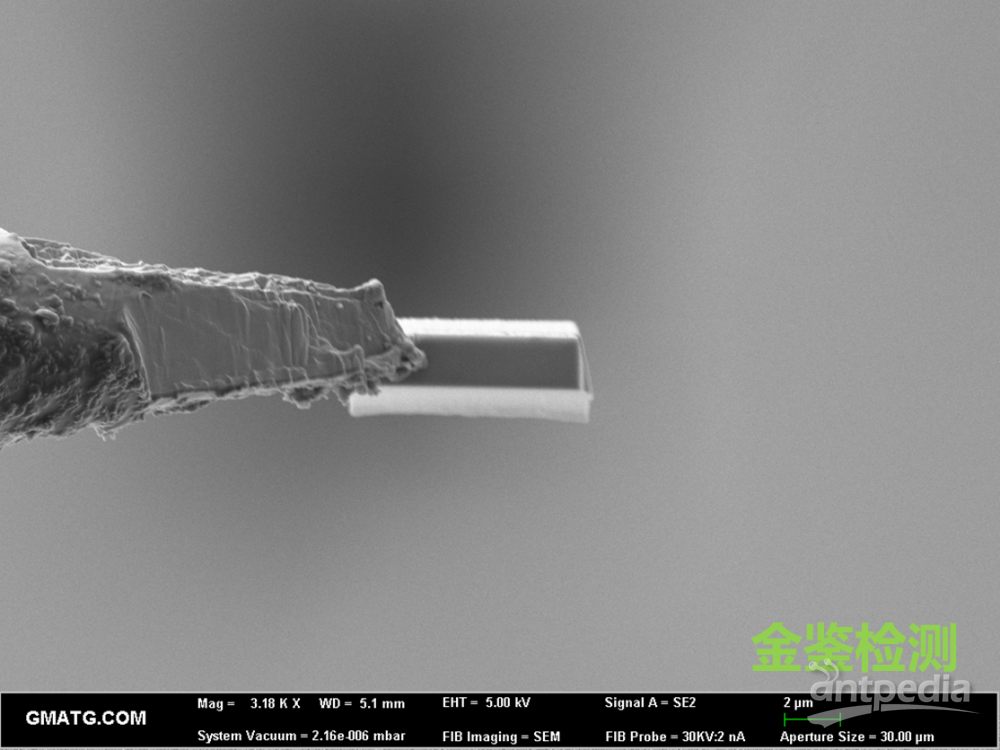
c、FIB精细加工完成制样

2.材料微观截面截取
SEM仅能观察材料表面信息,聚焦离子束的加入可以对材料纵向加工观察材料内部形貌,通过对膜层内部厚度监控以及对缺陷失效分析改善产品工艺,从根部解决产品失效问题。
案例二:
针对膜层内部缺陷通过FIB精细加工至缺陷根源处,同时结合前段生产工艺找出缺陷产生点,通过调整工艺解决产品缺陷。
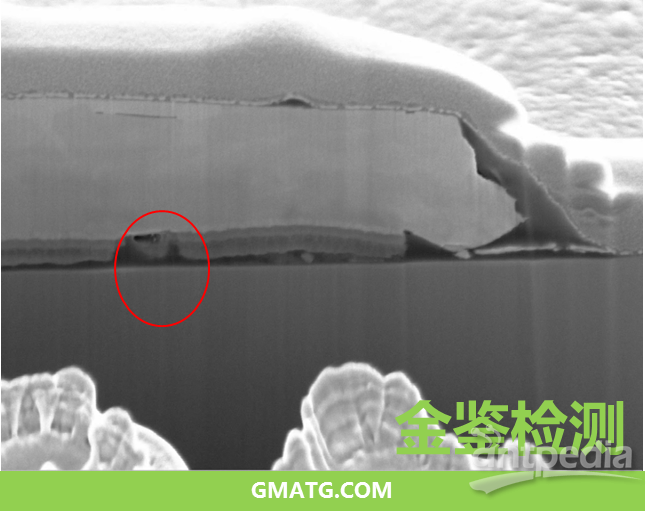
案例三:
产品工艺异常或调整后通过FIB获取膜层剖面对各膜层检查以及厚度的测量检测工艺稳定性。
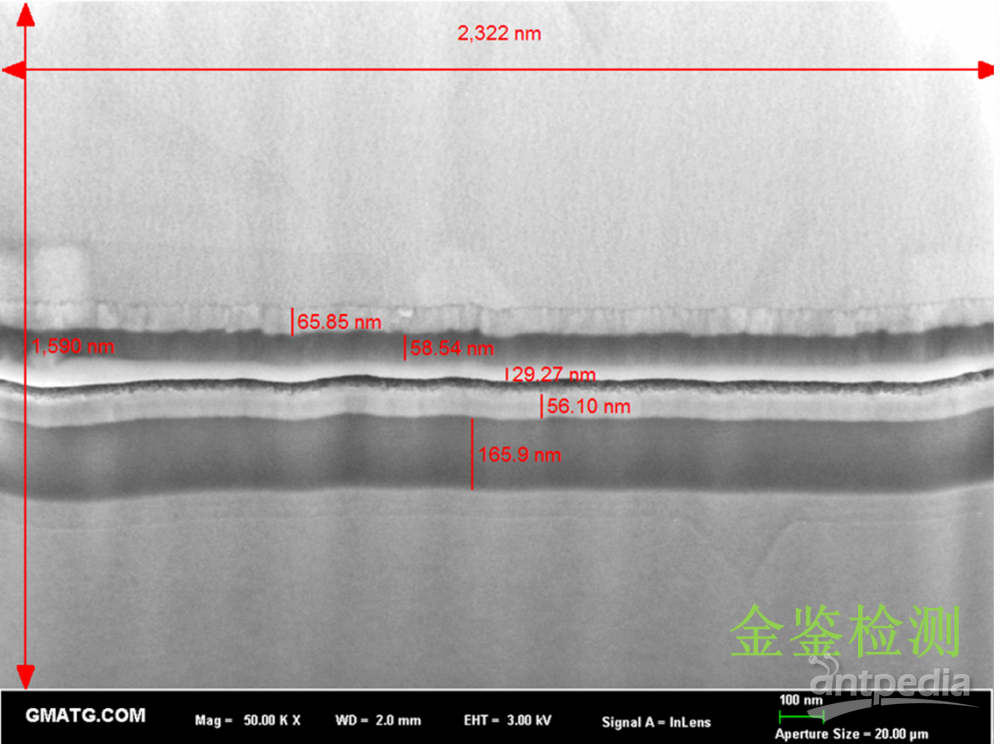
3.气相沉积(GIS)
FIB GIS系统搭载Pt气体,其作用除了对样品表面起到保护作用,还能根据其导电特性对样品进行加工。FIB加工前为材料提供保护层,或用于材料精加工。
案例四:
纳米材料电阻无法直接进行测量,通过FIB GIS系统对其沉积Pt,将其连接到电极上进行四探针法测电阻。

4.三维重构
FIB-SEM三维重构系统是通过FIB连续切出多个截面再通过软件将一系列2D图像转换为3D图像。
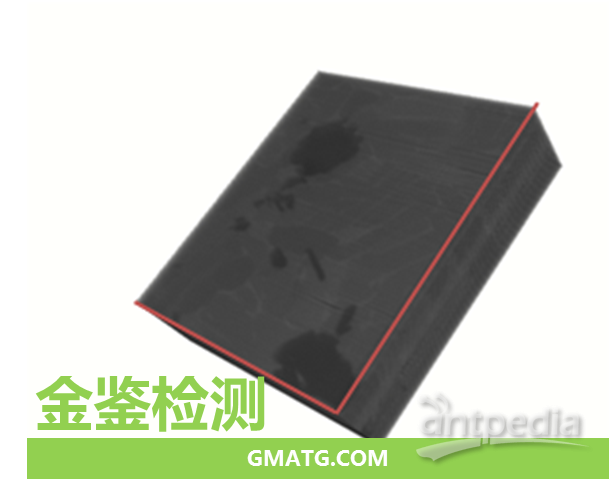

| 标签: | FIB制样,扫描电镜,TEM |

