测量方式: 红外干涉(非接触式)
样本尺寸: 50、75、100、200、300 mm
测量厚度: 30 — 780 μm (单探头)
3 mm (双探头总厚度测量)
扫瞄方式: 半自动及全自动型号,
另2D/3D扫瞄(Mapping)可选
衬底厚度测量: TTV、平均值、zui小值、zui大值、公差...
粗糙度: 20 — 1000? (RMS)
重复性: 0.1 μm (1 sigma)单探头*
0.8 μm (1 sigma)双探头*
分辨率: 10 nm
设备尺寸:
413-200: 26”(W) x 38” (D) x 56” (H)
413-300: 32”(W) x 46” (D) x 66” (H)
重量: 500 lbs
电源 : 110V/220VAC 真空: 100 mm Hg
*样本表面光滑(一般粗糙度小于0.1μm RMS)
** 150μm厚硅片(没图案、双面抛光并没有掺杂)
平整度
厚度变化 (TTV)
沟槽深度
过孔尺寸、深度、侧壁角度
粗糙度
薄膜厚度
环氧树脂厚度
衬底翘曲度
晶圆凸点高度(bump height)
MEMS 薄膜测量
TSV 深度、侧壁角度...
非接触式厚度测量,可以测量背面研磨减薄和刻蚀后的极薄晶圆,也可测量粘附在蓝膜或者其他载体上的有图形或凸起的晶圆,可应用于堆叠芯片和微机电系统。
独特优势:
FSM413回波探头传感器使用具有zl的红外(IR)干涉测量技术,可以直接和精确测量从厚到极薄的晶圆衬底厚度变化和总体厚度变化。配置单探头系统,可以测量一些对红外线透明的材料,例如Si,
GaAs, InP, SiC,
玻璃,石英和一些聚合物,还可以高精度测量常规有图形、有胶带、凸起或者键合在载体上晶圆的衬底厚度。配置双探头系统时,还提供晶圆整体厚度测量(包括衬底厚度和在光不能穿透的情况下的图形高度厚度)。选配功能可以测量沟槽深度和通孔深度(包括微机电中的高深宽比的沟槽和通孔)。另外微机电应用中薄膜厚度测量和凸块高度测量也可以选配。
基于FSM Echoprobe红外线干涉测量zl技术,提供非接触式芯片厚度和深度测量方法。
Echoprobe技术利用红外光束探测晶圆。
Echoprobe可用于测量多晶硅、蓝宝石、其它复合物半导体,例如GaAs, InP, GaP, GaN 等。
对晶圆图形衬底切割面进行直接且精确的测量。
行业应用:
主要应用在研磨芯片厚度控制、芯片后段封装、TSV(硅通孔技术)、(MEMS)微机电系统、 侧壁角度测量等。
针对LED行业, 可用作检测蓝宝石或碳化硅片厚度及TTV
其它应用:
· 沟槽深度测量
· 表面粗糙度测量
· 薄膜厚度测量
· 环氧厚度测量
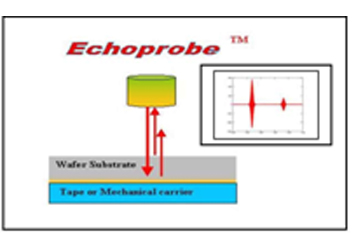
Echoprobe™ 回波探头技术可提供对极薄晶圆(<100um)的衬底厚度或粘结结构上的极薄衬底进行直接和精准的测量。


|
除厂家/中国总经销商外,我们找不到 FSM 413 系列 晶圆厚度测量系统 的一般经销商信息,有可能该产品在中国没有其它经销商。
如果您是,请告诉我们,我们的邮件地址是:sales@antpedia.net 请说明: 1.产品名称 2.公司介绍 3.联系方式 |
售后服务
我会维修/培训/做方法
如果您是一名工程师或者专业维修科学 仪器的服务商,都可参与登记,我们的平台 会为您的服务精确的定位并展示。





