TOF-SIMS
飞行时间二次离子质谱(TOF-SIMS)是一种非常灵敏的表面分析技术,适用于许多工业和研究应用。 TOF-SIMS是SIMS(二次离子质谱)分析技术与飞行时间质谱分析器(TOF)相结合的首字母缩写。该技术提供了有关样品表面、薄层、界面的详细元素和分子信息,并能提供全面的三维分析。其用途广泛,包括半导体,聚合物,涂料,涂层,玻璃,纸张,金属,陶瓷,生物材料,药品和有机组织。
在TOF-SIMS分析时,固体表面被几千电子伏特能量的一次离子轰击。一次离子的能量通过连续的原子碰撞转移到目标原子,从而形成所谓的“级联碰撞”。部分能量被输送回表面,使表面原子和分子化合物克服表面结合能溅射出表面。级联碰撞与表面分子的相互作用很弱而不破坏分子结构,即使质量高达10,000 u的大型非挥发性分子也可以在没有碎片或者只有很少量碎片的情况下离开表面。 SIMS是一种非常表面灵敏的分析技术,因为发射的粒子来自样品最表面的一个或两个单原子层。大多数的发射粒子是电中性的,但是有一小部分带正电或带负电,这就是二次离子。采用飞行时间质量分析(TOF)对二次离子进行接收,即可得到关于样品表面的元素和分子组成的详细信息。
飞行时间质谱(TOF)基于以下原理:具有相同能量但不同质量的离子以不同的速度行进。
静电场将产生的二次离子加速到相同的能量。加速的二次离子在飞行管内通过漂移路径到达二次离子检测器。较轻的二次离子以较高的速度飞行并先于较重的离子到达二次离子检测器。通过测量每个二次离子的飞行时间可以确定其质量。此加速-飞行-接收过程的重复频率高达50kHz。
先进的TOF质量分析器可补偿二次离子初始能量和发射角度的微小差异,从而实现高质量分辨率。线性漂移路径和离子镜(即二次离子反射器)的组合允许质量分辨率(M / dM)高于18,000。与四极杆型和磁偏转型分析仪相比,这种设计方案的主要优点是“极高的传输率,并行检测所有质量以及质量范围不受限制”。
脉冲式的一次离子束可以聚焦成为一个微小束斑(即微探针模式),再通过扫描可以确定元素和分子的横向分布。在这种操作模式下,可以实现低至50nm的横向分辨率。
在二次离子的漂移期间,提取场处于关闭状态,并且在此期间可以使用低能电子中和掉由一次或二次粒子引起的表面正电荷累积(即电荷补偿)。由此可以顺利地分析所有类型的绝缘固体材料。
在提取场关闭期间,也可施加低能量离子束作用于样品表面,对样品进行剥蚀。在这种情况下,低能量离子束将在样品表面形成一个溅射坑,这个溅射坑的中心由脉冲式一次离子束进行分析(即双束深度剖析)。
| 表面质谱 | ||
| 静态SIMS研究的目的是通过分析得到样品原始的,未改性的表面成分信息。由于SIMS在原理上本身是一种破坏性的技术,要去除已破坏区域的二次离子对完整谱的影响,可以采用准非破坏性的静态二次离子质谱技术。这可以通过施加非常低束流密度的一次离子来实现。表面质谱提供来自样品最表面几个原子层的详细元素和分子信息。 | 1、ppm / ppb 范围的高灵敏度 2、即使在绝缘样品上也具有高质量分辨率和质量精度 3、质量范围大 |  |
| 表面成像 | ||
| 通过已经精细聚焦的离子束在样品表面上进行扫描,如同电子显微镜中的电子束,(在获得表面元素、分子成分信息的)同时还可以获得高质量分辨率的二次离子图像(化学成分图)。 | 1、高横向分辨率(<60 nm) 2、快速图像采集(高达50 kHz的像素频率) 3、图像采集区域范围可从μm2到cm2量级 | 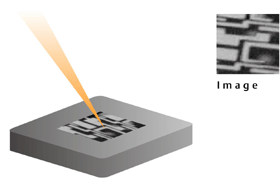 |
| 深度剖析 | ||
| 对于深度剖析,两个离子束在双束模式下工作。当第一个离子束在剥蚀一个溅射坑时,第二个离子束随后分析溅射坑的底部。 | 1、深度分辨率优于1 nm 2、高质量分辨率 3、溅射速度可达10μm/ h 4、非常适合绝缘体 | 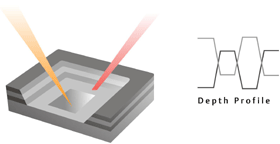 |
| 3D分析 | ||
| 通过综合质谱,成像和深度信息三个方面的数据,可以实现样品成分的三维结构可视化分析。3D分析是研究复杂且未知结构或缺陷的理想选择。特别是可以对特征区域和缺陷区域的成分,形状和位置进行成像。其应用包括:结构工艺(TFT显示器......)、缺陷分析(包埋颗粒......)、材料科学(晶界,扩散......) | 1、平行质量检测 2、高深度分辨率 3、高空间分辨率 |  |
| 回顾性分析 | |
| 除了综合在线分析外,TOF.SIMS 5和TOF.SIMS 300的并行质量检测还提供了进行回顾性分析的方法。 无论在测试之前有无样品相关信息,都可以在测试之后再重新组织分析数据以探寻意外或未知组分,例如未知结构,界面处的污染物等。 系统软件可以根据需要在任何坐标或坐标组重建质谱图、重建样品任何垂直或水平区域的成分像、重建任何选定区域的深度分析和重建各种3D成分视图。 | 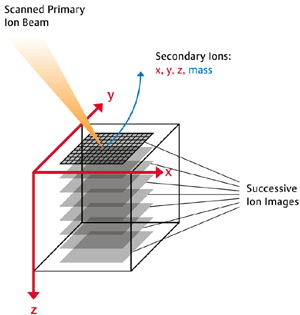 数据存储包括到达检测器的每个二次离子的x,y,z坐标及其质量。 数据存储包括到达检测器的每个二次离子的x,y,z坐标及其质量。 |
飞行时间二次离子质谱(TOF-SIMS)是一种非常灵敏的分析系统。通过对样品表面进行轰击产生的二次离子,可以精确确定表面元素的构成。通过对分子离子峰和官能团碎片的分析可以方便的确定表面化合物和有机样品的结构。配合样品表面扫描和剥离,可以得到样品表面甚至三维的成分图。系统应用的领域非常广泛,可以用于材料表面和表层的化学成份分析。化学元素或化合物在表面和块体材料内部的分布。以及生物组织表面和内部成份和分布分析。包括如半导体,医药,生物,冶金,汽车等领域。对样品的分析,如痕量金属探测,化合物结构测定,精确原子量测定,同位素标定,失效分析等方面研究应用广泛。许多用XPS,AES等分析不能确定的物质,都可以采用飞行时间二次离子质谱(TOF-SIMS)分析。
主要特点
1.可以并行探测所有元素和化合物,具有极高的传输率,只需要一次轰击就可以得到研究点的完整质量谱图。
2.可以探测的质量数范围包括10000原子量单位以下的所有材料。包括H, He等元素。
3.可以分辨同位素。
4.质量分辨率可以达到10000至15000以上。
5.具有很小的信息深度(小于1nm);可以分析材料zei表层(原子层)的结构
6.极高的空间分辨率,对于样品表面的组成结构一目了然。
7.达到ppm - ppb级的探测极限。
8.对于化合物,可以同时给出分子离子峰和官能团碎片峰;可以方便的分析出化合物和有机大分子的整体结构。
9.采用双束离子源可以对样品进行快速深度剖析。
10.采用高效的电子中和枪,可以精确的分析绝缘材料。
飞行时间二次离子质谱(TOF-SIMS)
【二次离子质谱简介】
飞行时间二次离子质谱(Time of Flight Secondary Ion Mass Spectrometry ,TOF-SIMS)是通过高能量的一次离子束轰击样品表面,使样品表面的原子或原子团吸收能量而从表面发生溅射产生二次离子,这些带电粒子经过飞行时间质量分析器后就可以得到关于样品表面信息的图谱。通过这些谱图可以得到化学元素或化合物在样品表面和内部的分布,也可以用于生物组织和细胞表面或内部化学成分的成像分析,配合样品表面扫描和剥离(溅射剥离速度可以达到10 μm/h),还可以得到样品表层或内部化学成分的三维图像。
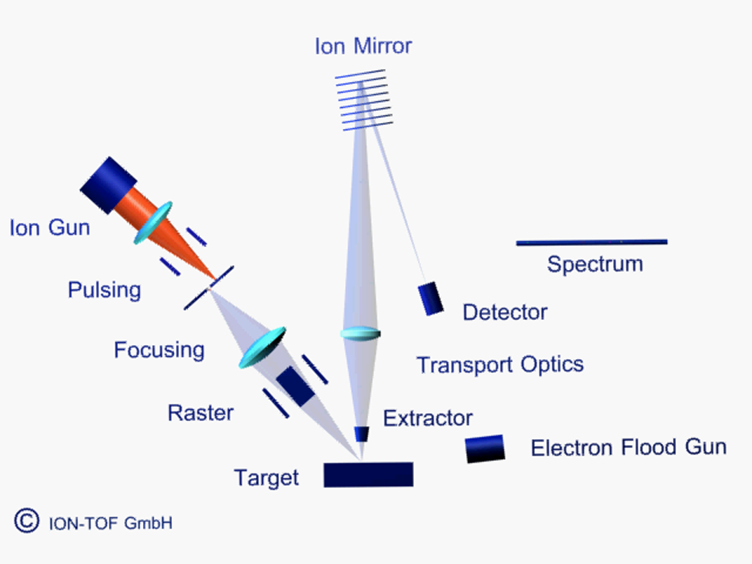
TOF-SIMS主要包括一次离子源、质量分析器和检测器等部分,对于绝缘样品还配有电荷补偿的电子中和枪,同时根据分析目的不同,还配有不同的离子源,常见的有气体放电源(如O2+、Ar+、Xe+)、表面电离源(如Cs+)、热隙源(如C60+)和液态金属及团簇源(如Bin+、Aun+、Ga+)等。
SIMS可以分为静态二次离子质谱和动态二次离子质谱(dynamic SIMS)两种模式,不同的分析模式,对应不同的分析要求。飞行时间二次离子质谱(TOF-SIMS)是质谱成像的主要仪器之一,与MALDI-MS成像技术相比,二次离子质谱的最大特点是其高空间分辨率(探测深度<1 nm, 平面分辨率<70 nm),能够在纳米尺度下,直接对生物组织(或材料),甚至单个细胞(由于MALDI-MS的激光扫描光斑直径在40微米左右,不能进行单个细胞的成像分析)进行三维成分分析,并且样品处理简单,不需要添加基质。二次离子质谱分析中,一次离子束轰击的传输效率极高(可以达到100%),只需要一次轰击就可以得到研究点的完整质量谱图。
【TOF-SIMS发展现状】
国际上对TOF-SIMS分析研究已经有近35年历史,其中ION-TOF是目前世界上领先的TOF-SIMS研究者和制造商,代表性的单位是德国ION-TOF公司所在的德国明斯特大学。
可以说,ION-TOF的历史就是TOF-SIMS的发展史。基于Prof. Beninghoven教授(明斯特大学原物理系主任,国际二次离子质谱协会主席)的理念,1982年明斯特大学研制出世界上第一套TOF-SIMS系统,一直到1989年发展到第三代的TOF-SIMS。也正式组建ION-TOF公司并推向市场。到现在,TOF-SIMS系统已经完全跳出最初的静态二次离子质谱的概念,引入第二束专门剥离的离子束,从而可以实现空间范围的三维分析。2003年10月,该公司推出了新一代TOF.SIMS 5仪器,代表当前国际上同类仪器的领先水平。在2005年,公司推出具有独立zl的Bi源。可以完全取代原来的Ga源和金源。该分析源对无机物和有机大分子等的分析都可以胜任,并且不损失系统的空间分辨率的前提下大大提高其质量分辨率。2012年,ION-TOF开发了第二代Bi源,二次离子检测器方面新研制了EDR功能,对系统结果校正和定量分析有较大帮助,并推出了可以用于有机大分子和生物分析的Gas Cluster Source。而分析源的升级是发展最快的: Ga, Au, Xe, SF5, C60,O,Cs, 一直到现在广泛应用的Bi和GCS(Gas Cluster Source)。
在国内,自上世纪90年代起,清华大学的查良镇教授做了很多优秀成果以及普及工作,如2008年10月26日-29日,其担任主席时期主办的北京二次离子质谱学国际研讨会,有来自美国、英国、法国、德国、日本、新加坡、中国台湾、中国香港和中国大陆等九个国家和地区的150余名代表参加了会议,与会人员热烈讨论,反映良好。近年来发展也较快,越来越多人逐渐认识到它功能强大,应用范围广,用户逐渐增多。

2016年年10月8日至11日在中国科学院大连物理研究所还召开了第六届中国二次离子质谱会议,上届国际SIMS大会主席、英国国家物理实验室IanGilmore教授,美国分析化学杂(AnalyticalChemistry)副主编、瑞典哥德堡大学Andrew Ewing教授,美国华盛顿大学David Castner教授,下届国际SIMS大会主席、日本京都大学Jiro Matsuo教授,美国太平洋西北国家实验室朱梓华教授,清华大学查良镇教授,台湾国立清华大学凌永健教授,中国地质科学院地质研究所刘敦一研究员,中科院地质与地球物理研究所周新华、李献华、杨尉研究员,中科院化学所汪福意研究员,东华理工大学陈焕文教授等110余名国内外SIMS研究人员出席了会议。Ian Gilmore、Jiro Matsuo与Andrew Ewing等SIMS领域国际知名专家学者为本次会议作了精彩的特邀报告。

【TOF.SIMS 5主要配置】
1. TOF.SIMS 5 – 100: 包括分析器,真空系统,软硬件等基本配置。
2. Bi Nanoprobe: 第二代液态金属团簇离子源,30kV,离子光学镜筒,3级透镜,具有动态质量分离功能。
3. Gas Cluster离子源: 20kV气体团簇离子源,主要用于有机样品深度剖析和三维分析的剥离源。
4. DSC-S: 用于深度剖析溅射用离子源的连接控制装置。
5. EI Source: 与DSC-S 连用的电子轰击对气体进行电离的离子源,可以作为O源,Xe源,Ar源等。
6. Cs Source: 与DSC-S 连用的热电离的Cs离子源。与EI源选择使用可以提高待测离子的产额
7. Gas Flood A: 可以提高离子产额的气体覆盖自动控制系统。
8. EDR辅助分析:用于加强二次离子的收集,包括高速二次离子质量选择挡板等软硬件改造。
【TOF.SIMS 5 技术指标】
1. 可以分辨同位素。
2. 达到ppm~ ppb级的探测极限。
3. 可以并行探测所有元素和化合物,具有极高的传输率(可以达到100%)。
4. 采用高效的电子中和枪,可以精确的分析绝缘材料。
5. 具有很小的信息深度(小于1nm);可以分析材料最表层(原子层)的结构。
6. 70nm以下的空间分辨率,对于样品表面的组成结构一目了然。
7. 可以探测的质量数范围包括12000原子量单位以下的所有材料,包括H, He等元素。
8. 可以同时给出分子离子峰和官能团碎片峰;可以方便的分析出化合物和有机大分子的整体结构。
9. 采用双束离子源可以对样品进行深度剖析,深度分辨率小于1 nm。
10.质量分辨率验收标准在12000以上,通常的系统分析在质量数(m/z>100)附近可以达到17000以上。
【应用领域】
飞行时间二次离子质谱在纳米材料(特别是半导体、电池材料)、微电子、生物医学、地质、冶金、集成电路、人工智能材料等领域有着非常广泛的应用(如下图实例所示)。二次离子质谱可以在新型电子信息材料、集成电路及半导体材料、高端金属结构材料、高性能复合材料、纳米医用材料、高端金属结构等表征方面提供科学的解决方案。特别地,飞行时间二次离子质谱是迄今为止能在纳米尺度下,对固体材料、生物组织或细胞进行化学成像分析的为数不多的现代分析技术之一,能够应用于各种状态物质的表征、分析。
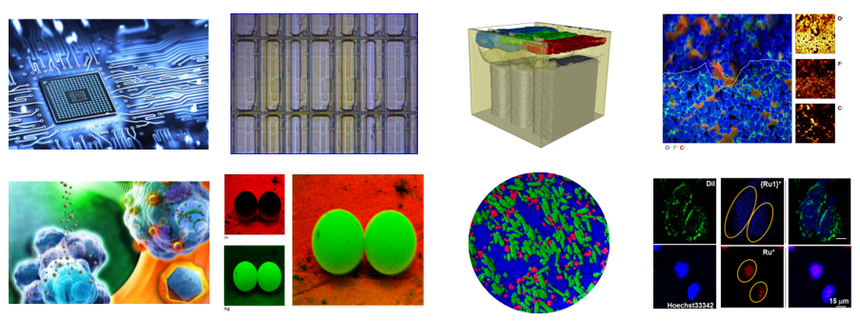
二次离子质谱主要有质谱图,表面成像、深度剖析和三维分析功能,可以获得样品上任意兴趣点的质谱图,兴趣区域的表面成分分布成像,以及通过深度剖析获知兴趣深度方向的不同层间的成分分布,甚至得到三维层次的成分分布。

下面给出一些利用飞行时间二次离子质谱所做的实例:
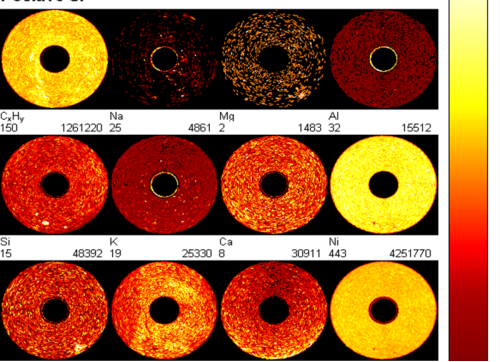
大尺寸样多膜层样品
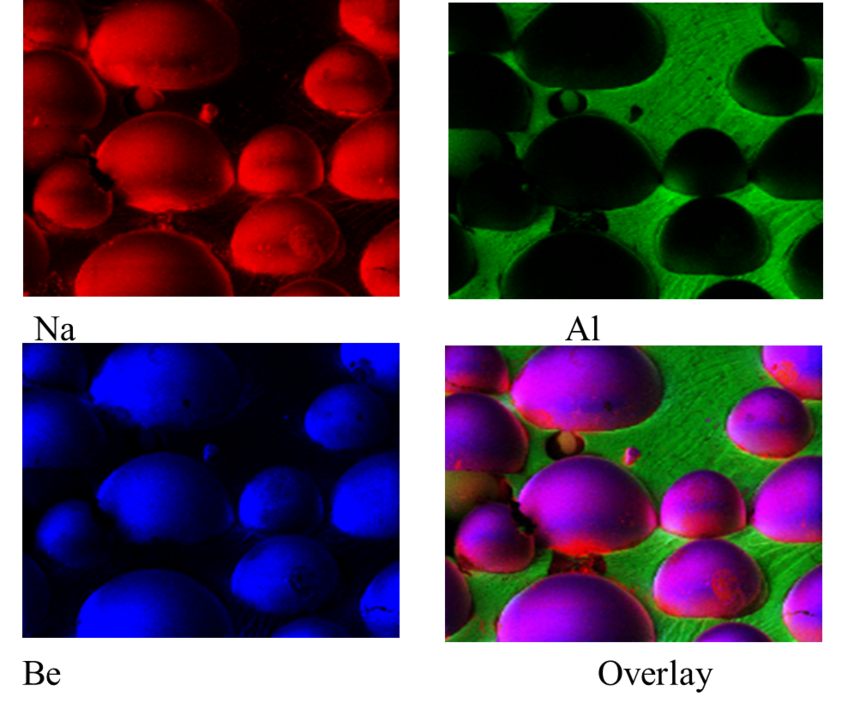
表面成像
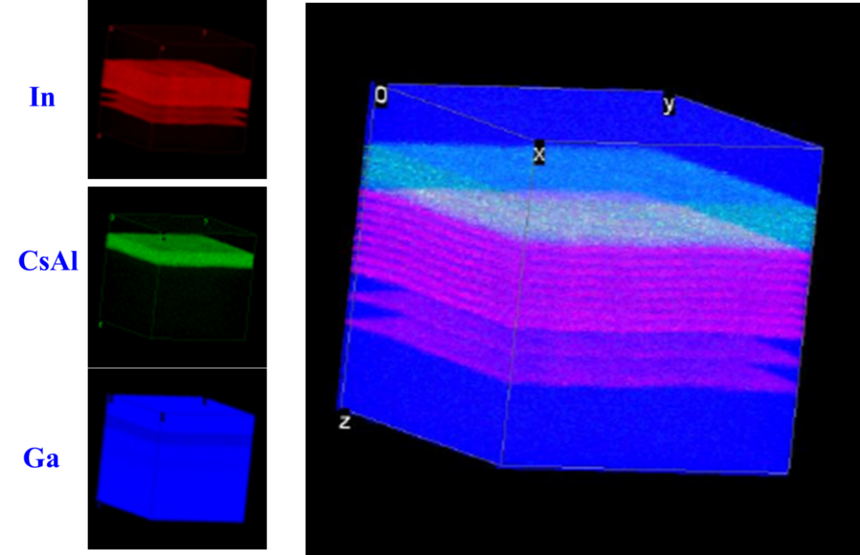
三维结构分析

单细胞分析
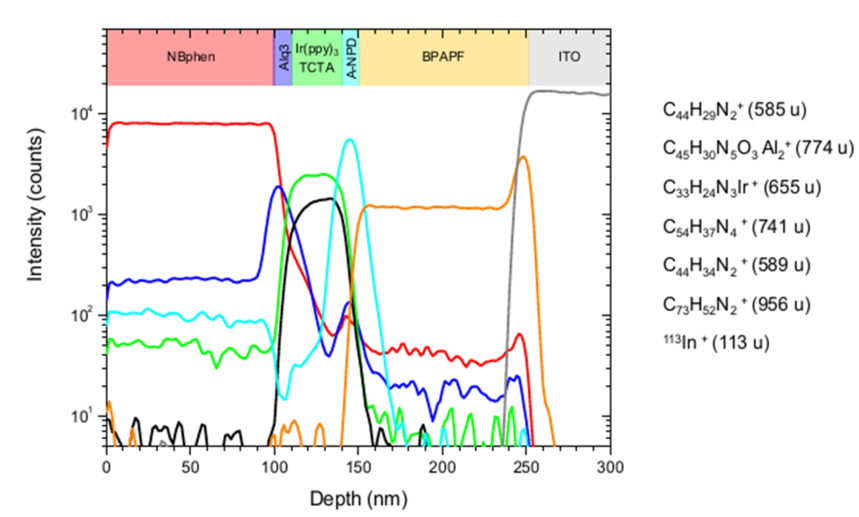
材料深度剖析
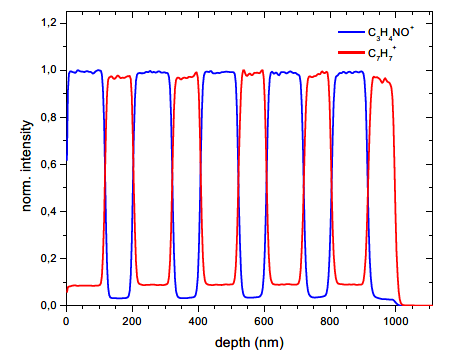
简而言之,TOF.SIMS 是一种非常灵敏的表面分析技术,已经被广泛应用于半导体,微电子,薄膜,纳材料,化学,医药,生物,冶金,汽车等领域。近年来,飞行时间二次离子质谱技术在生物医药领域大放异彩,在研究内源性生物分子及药物分子在细胞的分布方面具有广泛的应用前景,特别地还可用于单细胞研究,如北京分子科学国家实验研究人员应用我公司提供的TOF SIMS 5研究内源性生物分子以及药物分子在单细胞分布,作用靶标及其作用机理取得重要进展,使得该仪器在生命科学领域具有广泛的应用前景。此外,飞行时间二次离子质谱还可以与其他仪器联用(如激光共聚焦显微镜,原子力显微镜,扫描电镜等),功能整合的联用系统能够发挥各自仪器的优势,拓展其应用领域。

TOF-SIMS 5系统实物图
ION-TOF是世界领先的TOF-SIMS的研究者和制造商
IONTOF是由Alfred Benninghoven教授,Dr.Ewald Niehuis和Thomas Heller先生于1989年创立,创始人Prof.Benninghoven教授是国际静态二次离子质谱的奠基人,他们团队始终引领国际二次离子术的发展,从上世纪80年代初开始,Benninghoven教授和他的研究组就致力于飞行时间二次离子质谱的系统和应用研究。依托于明斯特大学和州纳米中心的技术和人才优势,TOF-SIMS已经发展成为无可替代的表面分析手段。
TOF.SIMS 5从2003年定型到现在已经成为市场上最成功的飞行时间二次离子质谱系统。到2016年,世界上已经有超过350套高性能的TOF.SIMS系统完美的应用在世界各地的公司和学术研究机构中。
发展历程
TOF-SIMS I 1982 明斯特大学

TOF-SIMS II

1986:TOF质量分析器的质量分辨首次达到 > 10.000
1986:低ppm范围内达到高质量准确度
1988:首次为绝缘样品分析进行电荷补偿
TOF-SIMS III

1990:5轴平台,样品处理更灵活
1990:Ga离子枪原位超快速消隐
1993:分析容量可容纳 8 硅片
TOF-SIMS IV

1994:首次采用双束模式深度剖析
1995:用于成像的 Burst模式获得zl许可
1997:用于大面积分析的微距扫描
1998:采用SF6离子源
1999:分析容量可容纳 12“ 硅片
1999:首次采用Au团簇离子源进行成像
TOF.SIMS 5 最新科技!

待续
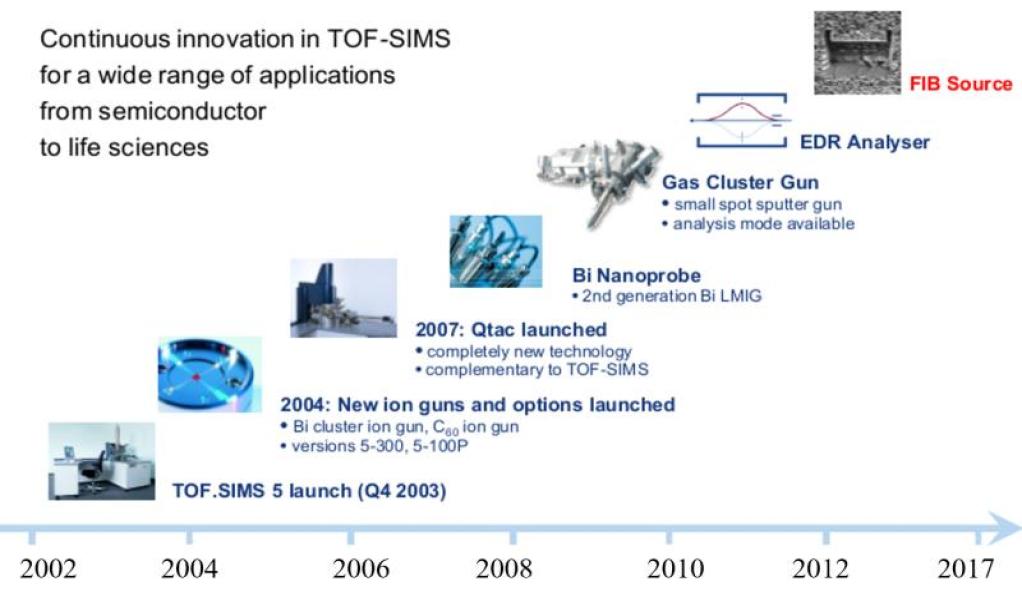


|
除厂家/中国总经销商外,我们找不到
TOF.SIMS 5 飞行时间二次离子质谱 的一般经销商信息,有可能该产品在中国没有其它经销商。
如果您是,请告诉我们,我们的邮件地址是:sales@antpedia.net 请说明: 1.产品名称 2.公司介绍 3.联系方式 |
售后服务
我会维修/培训/做方法
如果您是一名工程师或者专业维修科学 仪器的服务商,都可参与登记,我们的平台 会为您的服务精确的定位并展示。





