二次离子质谱的原理组成和结构
二次离子质谱
Secondary Ion Mass Spectrometry (SIMS)
1 引言:
离子探针分析仪,即离子探针(Ion Probe Analyzer,IPA),又称二次离子质谱(Secondary Ion Mass Spectrum,SIMS),是利用电子光学方法把惰性气体等初级离子加速并聚焦成细小的高能离子束轰击样品表面,使之激发和溅射二次离子,经过加速和质谱分析,分析区域可降低到1-2μm直径和5nm的深度,正是适合表面成分分析的功能,它是表面分析的典型手段之一。
应用离子照射样品产生二次离子的基础研究工作最初是R.H.斯隆(1938)和R.F.K.赫佐格(1949)等人进行的。1962 年R.卡斯塔因和G.斯洛赞在质谱法和离子显微技术基础上研制成了直接成像式离子质量分析器。1967 年H.利布尔在电子探针概念的基础上,用离子束代替电子束,以质谱仪代替X 射线分光计研制成扫描式离子探针质量显微分析仪[1]。
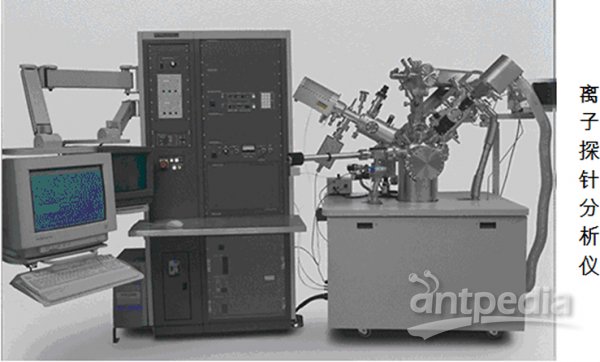
二次离子质谱(SIMS)比其他表面微区分析方法更灵敏。由于应用了中性原子、液态金属离子、多原子离子和激光一次束,后电离技术,离子反射型飞行时间质量分析器,离子延迟探测技术和计算机图像处理技术等,使得新型的IWHI的一次束能量提高到MeV,束斑至亚μm,质量分辨率达到15000,横向和纵向分辨率小于0.5μm和5nm,探测限为ng/g,能给出二维和三维图像信息。SIMS已发展为一种重要的材料成分分析方法,在微电子、光电子、材料科学、催化、薄膜和生物领域有广泛应用[2]。
2 SIMS的基本原理[3]
离子探针的原理是利用能量为1~20KeV的离子束照射在固体表面上,激发出正、负离子(溅射),利用质谱仪对这些离子进行分析,测量离子的质荷比和强度,从而确定固体表面所含元素的种类和数量。
2.1 溅射

被加速的一次离子束照射到固体表面上,打出二次离子和中性粒子等,这个现象称作溅射。溅射过程可以看成是单个入射离子和组成固体的原子之间独立的、一连串的碰撞所产生的。左图说明入射的一次离子与固体表面的碰撞情况。
入射离子一部分与表面发生弹性或非弹性碰撞后改变运动方向,飞向真空,这叫作一次离子散射(如图中Ⅰ);另外有一部分离子在单次碰撞中将其能量直接交给表面原子,并将表面原子逐出表面,使之以很高能量发射出去,这叫作反弹溅射(如图中Ⅲ);然而在表面上大量发生的是一次离子进入固体表面,并通过一系列的级联碰撞而将其能量消耗在晶格上,最后注入到一定深度(通常为几个原子层)。固体原子受到碰撞,一旦获得足够的能量就会离开晶格点阵,并再次与其它原子碰撞,使离开晶格的原子增加,其中一部分影响到表面,当这些受到影响的表面或近表面的原子具有逸出固体表面所需的能量和方向时,它们就按一定的能量分布和角度分布发射出去(如图中Ⅱ)。通常只有2-3个原子层中的原子可以逃逸出来,因此二次离子的发射深度在1nm左右。可见,来自发射区的发射粒子无疑代表着固体近表面区的信息,这正是SISM能进行表面分析的基础。
一次离子照射到固体表面引起溅射的产物种类很多,其中二次离子只占总溅射产物的很小一部分(约占0.01-1%)。影响溅射产额的因素很多,一般来说,入射离子原子序数愈大,即入射离子愈重,溅射产额愈高;入射离子能量愈大,溅射产额也增高,但当入射离子能量很高时,它射入晶格的深度加大将造成深层原子不能逸出表面,溅射产额反而下降。
2.2 SIMS原理示意图[2]
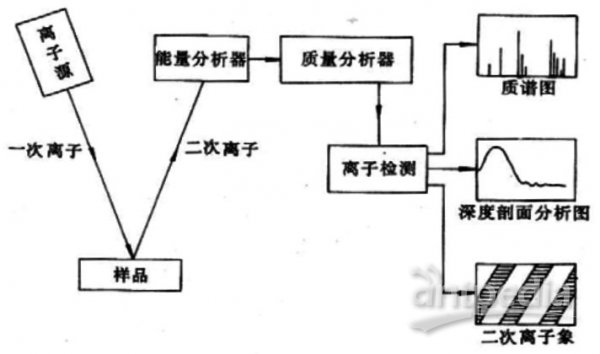
SIMS的基本原理如左图所示:(1)利用聚焦的一次离子束在样品上稳定的进行轰击,一次离子可能穿透固体样品表面的一些原子层深入到一定深度,在穿透过程中发生一系列弹性和非弹性碰撞。一次离子将其部分能量传递给晶格原子,这些原子中有一部分向表面运动,并把能量的一部分传递给表面粒子使之发射,这种过程称为粒子溅射。在一次离子束轰击样品时,还有可能发生另外一些物理和化学过程:一次离子进入晶格,引起晶格畸变;在具有吸附层覆盖的表面上引起化学反应等等。溅射粒子大部分为中性原子和分子,小部分为带正、负电荷的原子、分子和分子碎片;(2)电离的二次粒子(溅射的原子、分子和原子团等)按质荷比实现质谱分离;(3)收集经过质谱分离的二次离子,可以得知样品表面和本体的元素组成和分布。在分析过程中,质量分析器不但可以提供对应于每一时刻的新鲜表面的多元素分析数据,而且还可以提供表面某一元素分布的二次离子图像。
3. SIMS仪器的组成及分类
3.1 仪器组成[3]
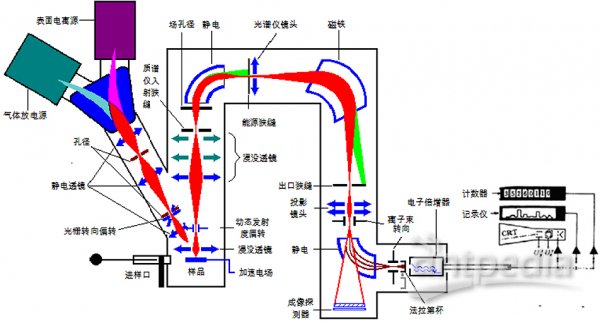
SIMS主要由三部分组成:一次离子发射系统、质谱仪、二次离子的记录和显示系统。前两者处于压强〈10-7Pa的真空室内。其结构原理如上图所示。
① 一次离子发射系统
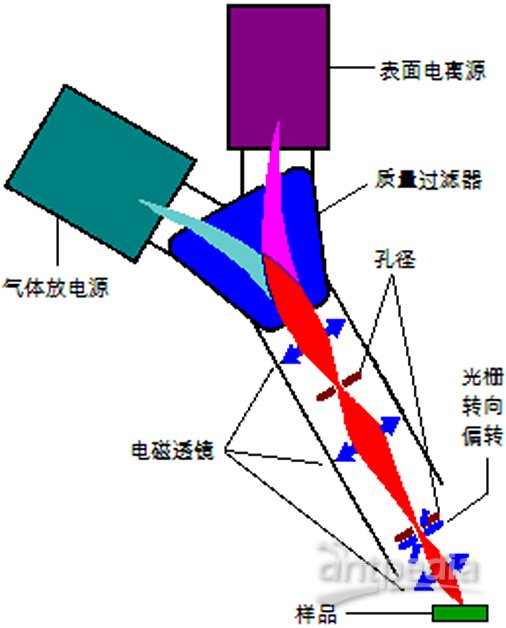
一次离子发射系统由离子源(或称离子枪)和透镜组成(如左图所示)。离子源是发射一次离子的装置,通常是用几百伏特的电子束轰击气体分子(如惰性气体氦、氖、氩等),使气体分子电离,产生一次离子。在电压作用下,离子从离子枪内射出,再经过几个电磁透镜使离子束聚焦,照射在样品表面上激发二次离子。用一个电压约为1KV的引出电极将二次离子引入质谱仪。SIMS的一次离子源分为气体放电源(O2+、O-、N2+、Ar+)、表面电离源(Cs+、Rb+)和液态金属场离子发射源(Ga+、In+)等。
② 质谱仪
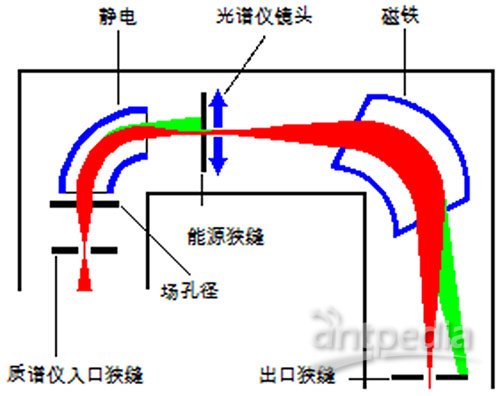
质谱仪由扇形电场和扇形磁场组成(如左图示)。二次离子首先进入一个扇形电场,称为静电分析器。在电场内,离子沿半径为r的圆形轨道运动,由电场产生的力等于向心力。
运动轨道半径r等于mv2/eE,与离子的能量成正比。所以扇形电场能使能量相同的离子作相同程度的偏转。由电场偏转后的二次离子再进入扇形磁场(磁分析器)进行第二次聚焦。由磁通产生的洛仑兹力等于向心力。
不同质荷比的离子聚焦在成像面的不同点上。如果C狭缝固定不动,联系改变扇形磁场的强度,便有不同质量的离子通过C狭缝进入探测器。B狭缝称为能量狭缝,改变狭缝的宽度可选择不同能量的二次离子进入磁场。
③ 离子探测系统
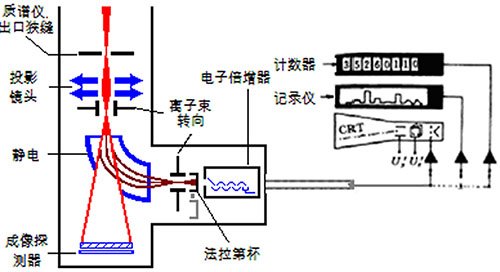
离子探测器是二次电子倍增管,内是弯曲的电极,各电极之间施加100-300V的电压,以便逐级加速电子。二次离子通过质谱仪后直接与电子倍增管的初级电极相碰撞,产生二次电子发射。二次电子被第二级电极吸引并加速,在其上轰击出更多的二次电子,这样逐级倍增,最后进入记录和观察系统。
二次离子的记录和观察系统与电子探针相似,可在阴极射线管上显示二次离子像,给出某元素的面分布图,或在记录仪上画出所有元素的二次离子质谱图。
3.2 SIMS主要优缺点
优点:
⑴信息深度为几个原子层,甚至单层(最表面原子打出);⑵能分析氢在内的全部元素,并可监测同位素(m不同);⑶能分析化合物,得到其分子量及分子结构的信息;⑷对许多成分检测灵敏度很高,有的杂质检测极限达ppm(10-6),ppb(10-9)量级,是表面分析中灵敏度最高的一种(微量B,O等);⑸可进行微区成分分析和深度剖面分析,还可得到一定程度的晶格信息。
缺点:
⑴定量差;⑵理论不完整;⑶破坏性分析。
在使用S-SIMS进行分析时,目前可以查找到多种有机化合物的标准谱图,可以参照手册对典型化合物进行定性分析。但在分析一些手册中没有的化合物,一般需要先测定化学结构已知的标准样品,并将测定结果作为解析的基本谱图。
3.3 SIMS仪器类型[2]
根据微区分析能力和数据处理方式,可以将SIMS分为三种类型:(1)非成像型离子探针。用于侧向均匀分布样品的纵向剖析或对样品最外表面层进行特殊研究;(2)扫描成像型离子探针。利用束斑直径小于10μm的一次离子束在样品表面作电视形式的光栅扫描,实现成像和元素分析;(3)直接成像型离子显微镜。以较宽(5~300μm)的一次离子束为激发源,用一组离子光学透镜获得点对点的显微功能。
根据一次束能量和分析纵向,二次离子质谱可分为DSIMS和SSIMS两种。在以往的SIMS研究中,DSIMS占据主导地位,而SSIMS作为一种新型的二次离子质谱正越来越受到重视。随着技术的不断完善和发展,SSIMS技术也越来越多地应用于其他科研领域,其中在地球化学领域涉及对煤、烃源岩和矿物沥青质体的分析。
3.3 SIMS的最新进展
⑴后电离技术(溅射中性粒子质谱,SNMS)
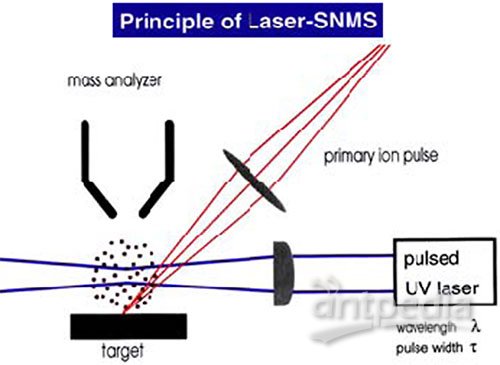
分析方法:对溅射得到的中性粒子实行后电离(如左图所示),再进行质谱分析,可以提高二次离子产额,减小不同元素二次离子产额之间的差别
后电离方法:激光、等离子体和电子
优点:减小基体效应的影响
⑵飞行时间二次离子质谱(TOF-SIMS)
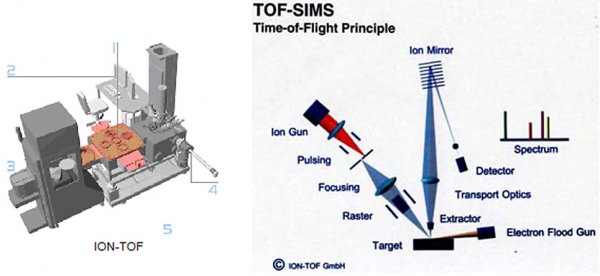
![]()
上图为ION-TOF设备及飞行时间原理图。TOF-SIMS具有高分辨率(如M/△M≥15 000,m/z>150);超高灵敏度(检出限ng/g量级);亚微米空间分辨率的离子成像;对无机元素和有机物同时分析等功能。与其它仪器相比,TOF-SIMS非常适用于复杂离子的精确分析。
离子探针作为一个具有分析微量元素的高灵敏度的微区分析方法正在迅速发展。但是,由于二次离子溅射机理较为复杂,定量分析仍存在许多问题。今后发展和改进的主要方向是:提高质谱分辨率,以减少和排除二次离子质谱干扰;实现多种质谱粒子探测,以获得样品和多种粒子的信息和资料;定量分析和离子溅射机理的研究;新型液态金属离子源的应用;离子探针与多种仪器(如X 射线光电子能谱、紫外光电子能谱、俄歇电子能谱)联用等[1]。
参考文献:
1 http://baike.baidu.com/view/906501.htm
2 二次离子质谱(SIMS)分析技术及应用进展 周强; 李金英; 梁汉东; 伍昌平 质谱学报 2004-06-30
3 http://www.hudong.com/wiki/%E7%A6%BB%E5%AD%90%E6%8E%A2%E9%92%88%E5%88%86%E6%9E%90%E4%BB%AA#catalog