气相二氧化硅在化学机械平坦CMP设备中的应用
CMP(Chemical Mechanical Polishing,化学机械抛光)是机械削磨和化学腐蚀的组合技术,它借助超微粒子的研磨作用以及浆料的化学腐蚀作用在被研磨的介质表面(如单晶硅片、集成电路上氧化物薄膜、金属薄膜等)上形成光洁的平面,它克服了传统的化学抛光所具有的抛光速度慢、容易导致抛光雾斑以及机械抛光所具有的易产生机械损伤、抛光精度低的缺点,并且可以根据需要对抛光的要素进行适当的控制,现已成为半导体加工行业的主导技术。
图1是一种CMP设备简图。其基本组成部件是一个转动着的圆盘和一个圆晶片固定装置,两者都可施力于圆晶片并使其旋转,在研浆的帮助下完成抛光,研浆供应系统可以保证抛光垫的润湿程度均匀,适当供应新的研浆保证其成分不变。
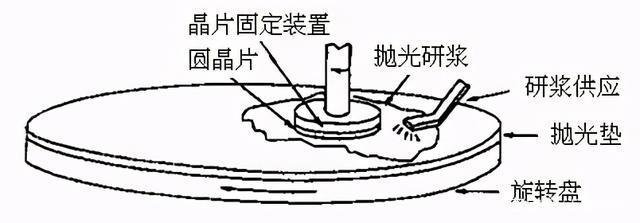
图1 一种CMP设备简图
CMP技术所采用的设备及消耗品包括:CMP设备、CMP浆料、抛光垫、后CMP清洗设备、抛光终点检测及工艺控制设备、CMP浆料分布系统、废物处理和测量设备等,其中CMP浆料、抛光垫和抛光机是CMP工艺技术的关键要素。表1是典型的CMP浆料品种,其中SiO2CMP浆料的种类及用量最多。
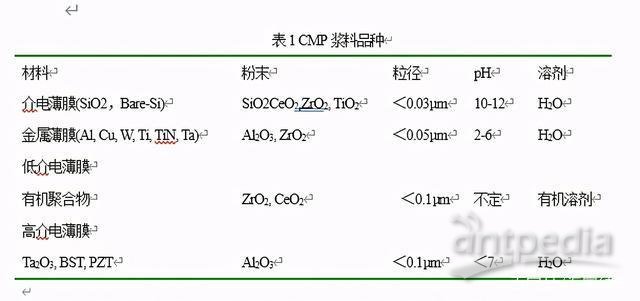
表1 CMP浆料品种
iO2浆料的制备方法可以分为凝聚法和分散法。凝聚法是利用溶液中化学反应所生成的SiO2通过成核、生长而制得SiO2浆料;分散法是利用机械分散的方法将二氧化硅粉末在一定的条件下分散于水中而制得SiO2浆料。
利用分散法制备SiO2CMP浆料所选用的纳米二氧化硅有沉淀法二氧化硅和气相二氧化硅等,其中气相二氧化硅是最理想的选择。由于纳米粉体制备技术的发展,特别是气相法纳米粉体制备技术和表面处理技术的发展,使得高纯度、粒子粒径大小和粒径分布可控、表面性质可设计化生产成为可能。







