有铅和无铅混合组装的工艺可靠性区别(二)
Jessen研究了焊膏材料与PBGA、CSP引脚钎料球材料对再流焊接后空洞的影响程度,按下述不同组合而递减:SnPb球/SAC焊膏>SAC球/SAC焊膏>SnPb球/SnPb焊膏Jessen还以下述模型(见图3、图4)对上述现象作了解释。
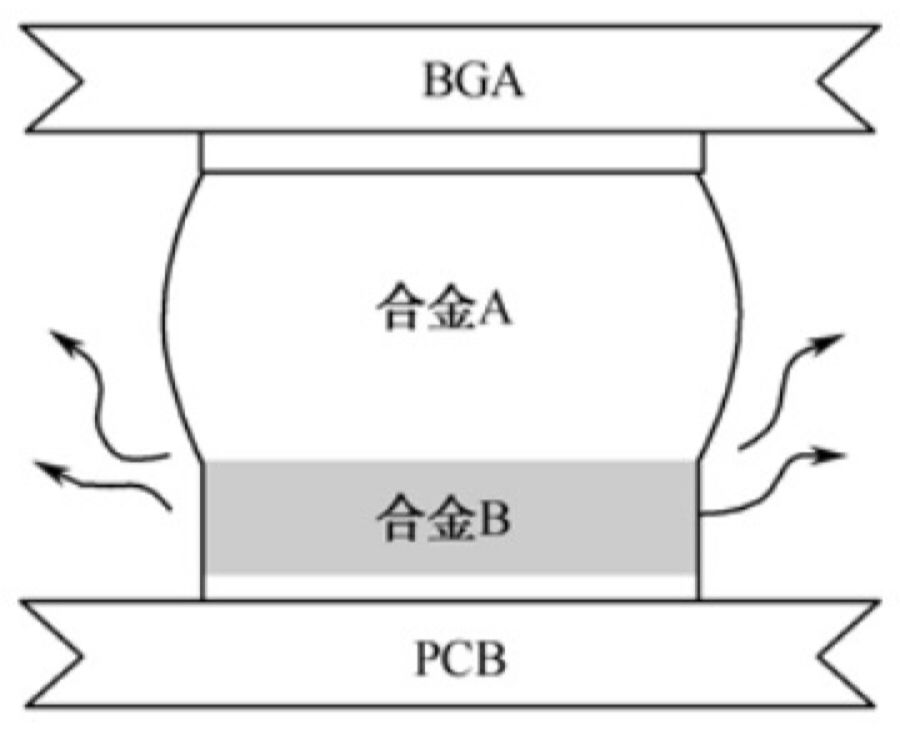
图3 熔点:合金A>合金B
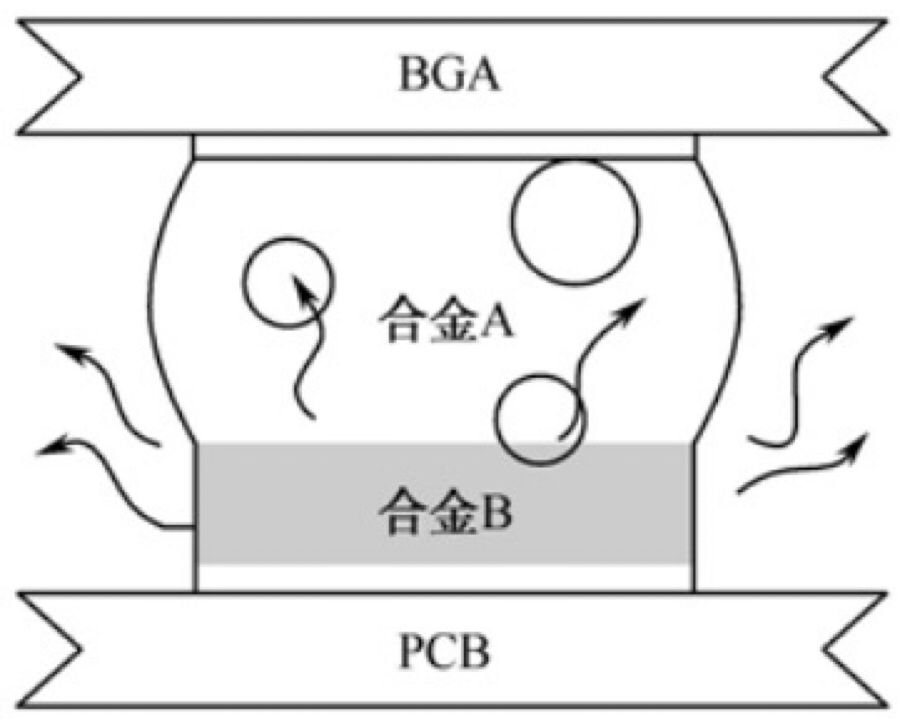
图4熔点:合金A<合金B
当钎料球的熔化温度高于焊膏的熔化温度时,不会有助焊剂挥发气体渗透进钎料球中形成空洞,如图3所示。
但是,如果钎料球的熔化温度低于焊膏的熔化温度,如图4所示,则一旦钎料球达到熔化温度,助焊剂中产生大量的挥发气体将进入熔化的钎料球钎料中,形成非常明显的空洞。这个空洞形成过程将一直持续下去,直到焊膏钎料熔化后与钎料球钎料结合。而结合后才会导致助焊剂挥发物从熔化钎料内部被驱赶出来,空洞形成过程就会由于缺少挥发物质而慢慢地平息下来。
2.组合的相容性从上述模型中可以看出,只有当球的熔点不低于焊膏的熔点时,混合应用才是可以接受的,否则就将导致不可接受的空洞。BGA、CSP等面阵列芯片的有铅、无铅混合组装类型的相容性如图5~图8所示。
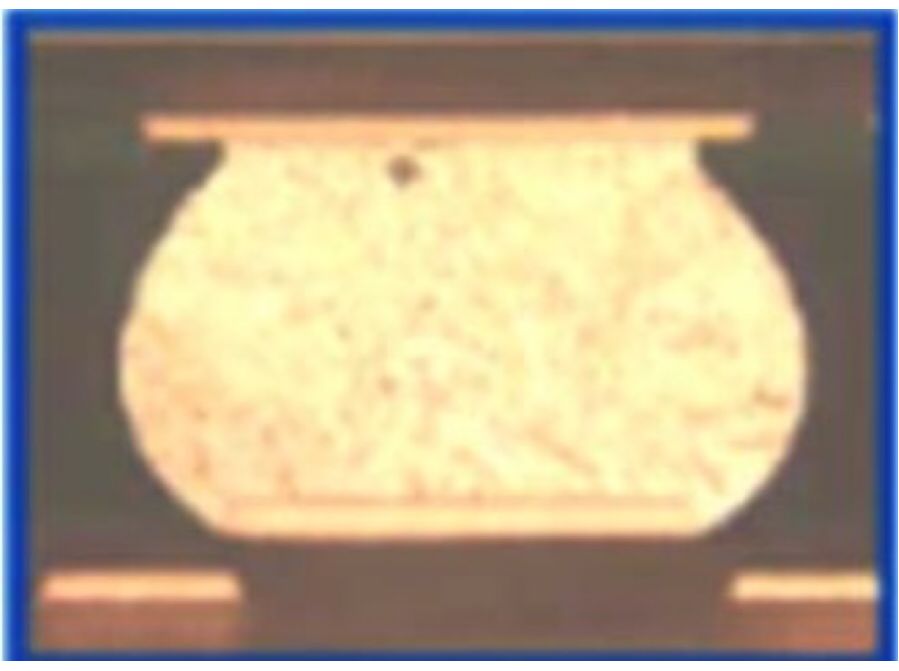
图5 SnPb球/SnPb焊膏(纯有铅)

图6 SAC球/SnPb焊膏(向后兼容)

图7 SAC球/SAC焊膏(纯无铅)
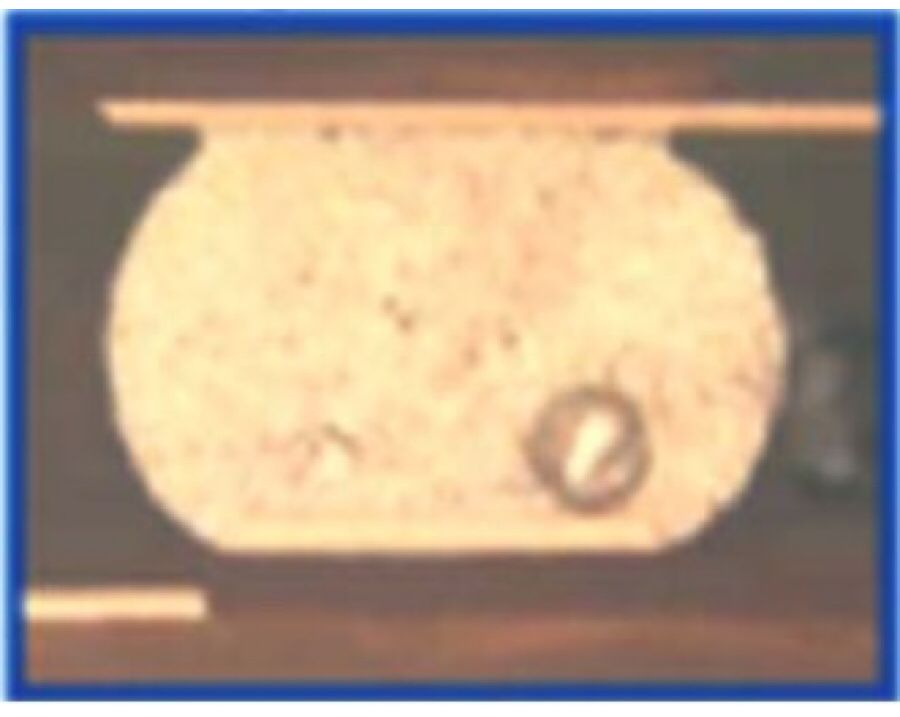
图8 SnPb球/SAC焊膏(向前兼容)
图5和图7分别示出了纯有铅和纯无铅再流焊接后的焊点切片图像,从金相切片分析可见,这两种焊点质量都比较好,而全面评估似乎图7比图5更优秀些。图8所反映的组合再流焊后的焊点质量最差。就混合组装工艺而言,目前电子业界应用最为广泛的是:SAC钎料球、Sn37Pb焊膏这一向后兼容的组合。根据樊融融编著的现代电子装联工艺可靠性改编







