电子产品无Pb制程的工艺可靠性问题分析(四)
(6)元器件引脚电镀和引脚材料的接合(1)引脚材料:Cu。焊盘类型为SMD,安装传统SnPb电镀元器件引脚和无Pb的SnBi电镀元器件,采用传统Sn37Pb钎料或无Pb的SAC305钎料的焊点可靠性、温度循环试验的结果,如图8所示。
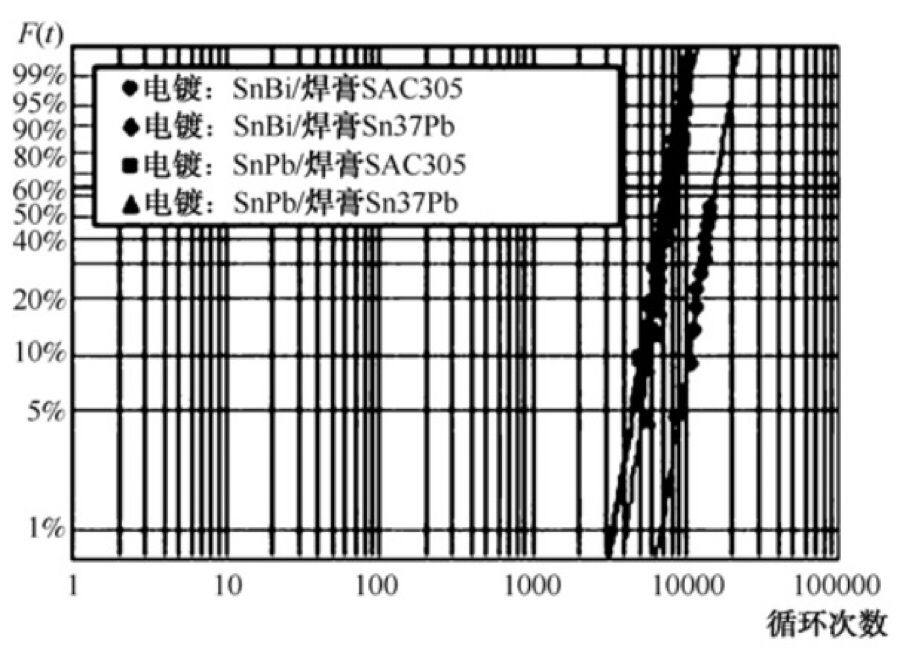
图8引脚材料为Cu的焊点温度循环试验的威布尔分布
无Pb产品和无Pb钎料的接合的温度循环特性优于传统工艺接合,并且传统产品和无Pb钎料,以及无Pb产品和传统钎料的接合都得到了较差的结果。(2)引脚材料:Fe-Ni。焊盘类型为SMD,安装传统SnPb电镀元器件引脚和无Pb的SnBi电镀元器件引脚,采用传统Sn37Pb钎料和无Pb的SAC305钎料的可靠性、温度循环试验结果如图9所示。
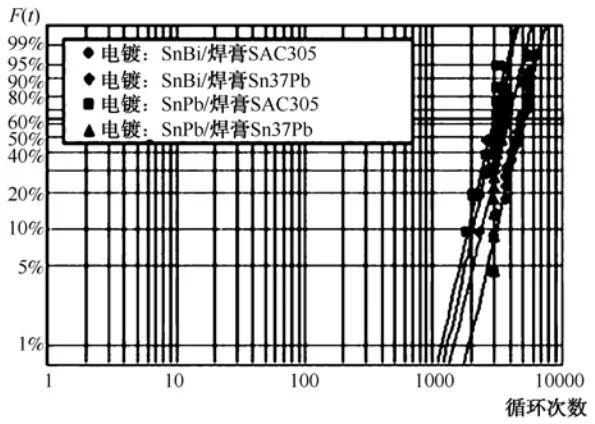
图9 引脚材料为Fe-Ni的焊点温度循环试验的威布尔分布
无Pb元器件引脚和无Pb钎料的接合的温度循环试验特性优于传统工艺接合,并且传统元器件引脚和无Pb钎料,以及无Pb元器件引脚和传统钎料的接合都得到了较差的结果。
5.工艺因素
1)工艺可靠性设计合适的PCBA组装工艺可靠性设计,可从两个方面来改善BGA、CSP等球栅阵列芯片焊点的可靠性,两者结合起来可以很大程度地提高器件的可靠性。这些方法如下:
(1)选择相近的热膨胀系数(CTE)材料来减少整体热膨胀的不匹配。
(2)通过控制合适的焊点高度(器件的离板高度)来增加焊接层的一致性,以此来减少整体热膨胀的不匹配。另外,以高可靠性为目的的可靠性设计规范还包括:
(3)通过在元器件和PCB基板之间添加合适的底部填充胶进行机械连接,从而消除整体热膨胀不匹配的影响。
(4)选择一种软的晶片黏结层来降低晶片热膨胀系数(2.7~2.8ppm/℃)在整体热膨胀不匹配和局部热膨胀不匹配的影响。选择特定范围热膨胀系数包括材料的选择或多层板和元器件之间材料的组合,来得到最佳的热膨胀系数。当多层板有较大的热膨胀系数时,有源器件最佳的热膨胀系数约为1~3ppm/℃(与功率的耗散有关),无源元件的热膨胀系数为0ppm/℃。当然,一个电子组装中有大批不同的元器件,要想实现热膨胀系数全部最优化是不可能的,这会给元器件带来极大的可靠性威胁。
对一些有密封性要求的军事应用产品,就需选用陶瓷元器件。选择特定范围热膨胀系数,就意味着热膨胀系数受到限制的多层板材料只能在Kevlar和石墨纤维(一种质地牢固重量轻的合成纤维),或者在铜-因瓦合金-铜和铜-钼-铜之间选择。这些解决方法对绝大多数商用产品来说显得太昂贵了,商用产品的多层板大多选用玻璃-环氧树脂或玻璃-聚酰亚胺材料。选择特定范围热膨胀系数的材料必须避免选取一些较大的元器件,如陶瓷元件(CGAs、MCMs)、引脚数为42的塑料封装(TSOPs、SOTs)或者是与晶片采用刚性连接的塑料封装(PBGAs)。对无Pb焊接接合部来说,要增加其相容性就意味着要增加焊点的高度或转向有Pb焊接接合部技术。因为有Pb焊接接合部增加了Pb的相容性,那就意味着要由元器件供应商转向更能提高Pb相容性的几何形状或转向细间距技术。可靠性设计过程不仅要强调器件失效的物理原因,还不能忽视失效的数据统计分布。







