DualBeam 显微镜
Helios G4 FX 材料科学应用
使用独特的一体化解决方案,以zei快的时间获得有用的数据。
Helios G4 FX 是世界上第一个通过类 TEM CompuStage 实现 TEM 薄片样品制备的 DualBeam™,而且它还与全新的透镜内 STEM 4 探测器结合,大大减少了获得高质量可用数据的时间。集成 CompuStage 包括在标准配置中,它独立于块状样品载物台,并附带有单独的 X、Y、Z 轴、全对中的 180° α 倾角轴和 200° β 倾角轴,因此可在 TEM 薄片样品的两侧进行 SEM 终点检测。随附的 STEM 杆与标准的 3 mm TEM 载网兼容,可实现快速载网交换,而无需破坏真空。此外,该系统配备了一个可伸缩的环形 STEM 4 探测器,具有新的透镜内模式,可实现终极成像性能和亚 3Å 分辨率。
体验 Helios G4 FX 带来的优势
使用独特的一体化解决方案,以zei快的时间获得有用的数据,可实现zei高质量的 TEM 样品制备和高分辨率成像,而无需从真空中取出样品
借助无与伦比的低电压性能,使用新 Phoenix 离子镜筒zei快zei简单地制备高质量、位置特异性超薄 TEM 和 APT 样品
借助一流的 Elstar™ 电子镜筒,以zei短的时间获取纳米级信息
使用较高电流的下一代 UC+ 单色仪技术揭示zei细致入微的细节,从而在低能量下实现亚纳米级性能。
从zei多 7 个集成的镜筒内和透镜下方探测器获取清晰、精良且不受电荷影响的对比度的zei完整的样品信息。
提供zei高质量多模态亚表层和三维信息,它使用可选 Auto Slice & View™ 4 (AS&V4) 软件对感兴趣的区域进行zei精确的定位。
用小于 10 nm 的关键尺寸,对复杂的结构进行快速、准确和精确的铣削和沉积
根据各个应用需求量身定制精确样品导航,这归功于 150 mm 压电工作台和室内导航凸轮的zei高稳定性和精度。
基于集成的样品清洁度管理和专用的成像模式(如 SmartScan™ 或 DCFI)的无伪影成像。

明场 STEM 图像显示在 30kV 下用 Helios G4 FX 获得的碳纳米管 (3.4Å) 的晶格条纹。
Helios G4 FX 属于业界领先的 Helios DualBeam™ 系列的第四代产品。它经过精心设计,通过提供zei好的一体化 STEM 样品制备和成像解决方案来满足科学家和工程师的需求。Helios G4 FX 将具有用于极高分辨率成像和zei高材料对比度的大电流 UC+ 技术的创新 Elstar 电子镜筒、用于亚 3Å 原位低 kV STEM 成像的透镜内 STEM 4,以及卓越的 Phoenix 离子镜筒结合在一起,实现zei快、zei简单、zei精确的高品质样品制备和三维表征,即使针对zei具挑战性的样品。
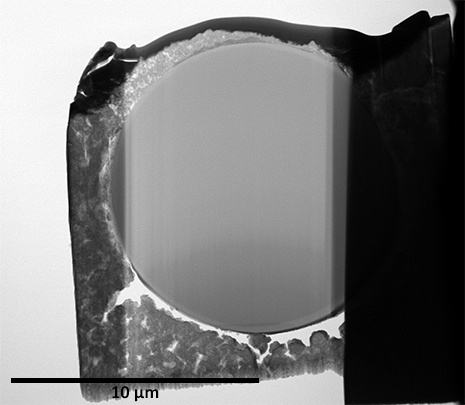
zei高质量的超薄 TEM 薄片样品 (催化活化过滤器样品)使用基于 iFast 的导引 TEM 样品制备工作流程,通过 Helios G4 生产。
DualBeam 显微镜
Helios G4 FX 的半导体应用
以更短的数据产生时间开发 7 nm 器件
Helios G4 FX 是 FEI zei先进的失效分析 DualBeam 平台,能够为 7nm 工艺开发与改进制作高质量的超薄 TEM 薄片样品。Helios G4 FX 包含全新的高性能 Phoenix 聚焦离子束 (FIB) 镜筒,让 DualBeam 操作员可以快速高效地制作损伤zei少并且切口保真度zei高的超薄片样品。Helios G4 FX 结合了zei高分辨率的 Elstar+UC 扫描电子显微镜 (SEM) 镜筒与 FEI EasyLift Nanomanipulator,令终点测量和 原位 样品提取变得前所未有的简单。FEI 独有的 MultiChem 气体输送系统提供优化的射束辅助沉积和蚀刻功能。除了简化高级失效分析和 TEM 样品制备的过程外,EasyLift 和 MultiChem 还可以提高操作员的信心和一致性,从而降低整个系统的拥有成本。Helios G4 FX 还是第一个包含亚 3Å 分辨率 STEM 成像的 Dualbeam 系统,大大缩短了先进探索实验室取得高质量数据的周转时间。在 DualBeam 内快速产生高质量、可操作的 30 kV STEM 图像可以为您的 FA 实验室和工艺开发人员带来明显的优势。
世界zei先进的 DualBeam 平台,用于半导体探索和工艺开发实验室内的成像、分析以及 TEM 样品制备。

FEI Helios G4 FX 集行业领先的zei高分辨率 Elstar+UC SEM 与zei先进的 Phoenix FIB 于一身,旨在提供一流的成像和铣削性能。在这一经过现场验证的第四代 Helios 平台的基础之上,增添了zei先进的原位提取和样品处理组件、创新的多气体输送系统、大幅提高的 3Å 分辨率、低电压 STEM 探测器,以及可自定义的配方,从而造就了当今功能zei强大、zei灵活的失效分析仪器。
切片成像
采用 UC 单色仪技术的创新 Elstar 电子柱为系统前所未有的高分辨率成像能力奠定了基础。这样一来,在zei佳工作距离和双射束重合位置分别将会带来丝毫不受影响的 0.6 nm 和 0.8 nm SEM 分辨率。高分辨率、低损害电子束成像对于大块样品内的缺陷或结构问题检测以及超薄 TEM 薄片样品上的终点测量至关重要。此外,以极低的着陆能量操作也非常重要,这有利于zei大限度减少敏感材料(例如低介电质或光刻胶)上射束诱发的损伤。


缩短数据产生时间
Helios G4 FX 配有全新的 Compustage 以夹持 TEM 载网,配有 G4 STEM 探测器以支持反面薄片样品制备,采用关键的工作流程为 STEM 或 TEM 制作高质量的超薄样品,还提供新功能来缩短有用数据产生时间。专用的 Compustage 和双倾斜 STEM 杆夹持器提供五个旋转轴,便于 SEM 在薄片样品两面进行终点测量,并让操作员能够轻松制作反面或正面样品。随着薄片样品厚度不断变小,单独 S/TEM 系统(通常在 80 或 120 kV 以上的电压下运行)的较高能量电子只与样品中的极少材料相互作用。越来越薄的薄片样品需要越来越低的电子束加速电压,以便让电子更多地与样品中的不同材料相互作用,这是极大提高材料对比度和描绘界面的必要步骤。事实证明,对比 DualBeam 系统中以前的 STEM 探测器,全新的 G4 STEM 探测器与 30 kV 电子束相结合,对原子质量相似的材料具有更高的灵敏度。它能够在 DualBeam 中通过低电压 STEM 图像完成失效分析工作,无需将成品样品暴露在环境空气之中,从而缩短数据产生时间,并减少对独立 S/TEM 系统的需求。

显示亚 3Å 分辨率的碳原子的碳纳米管 STEM 图像

14 nm FinFET 的明场 STEM 图像

14 nm FinFET 器件的高角度环形暗场 STEM 图像显示多层和互连结构
更高的通量
支持探索或 14 nm 以下工艺开发的半导体失效分析实验室需要制作高质量的位置特异性 TEM 薄片样品,这一要求带来了独特的挑战和机会。这些样品必须超薄,片层厚度通常需等于或小于设计节点,以便从结果分析中去除相邻结构。此外,样品还必须尽可能接近于“无伪影”,以在 S/TEM 或 TEM 中正确诊断和计量。zei后,为了支持任何新产品的快速开发和工艺改进,TEM 薄片样品制作过程必须更快、更一致。因此,创新技术和自动化需要提高超薄 TEM 样品制作的速度,并降低制作难度。
Helios G4 FX 能够在完全正确的位置制作 10 nm 以下的 TEM 薄片样品,zei大限度减少制备过程中的伪影,并提供比以往产品高得多的通量。在 MD 和 ICD BSE 探测器的支持下,高分辨率和高对比度的图像让操作员能够准确且更加快速地确定薄片样品每一面的正确终点。根据特定的样品类型,可以在 75 分钟内制作出高质量的超薄片样品,为 S/TEM 成像做好准备。
通过改用获得zl的反面样品制备流程,Helios G4 FX 能够制作比自上而下的传统方法更宽(上至 5-10 um 宽)、更薄(下至 7 nm 或更薄)的样品。在使用集成的 FEI EasyLift Nanomanipulator 提取样品后,Helios G4 FX 可利用全新的 Compustage 双倾斜夹持器快速反转样品。
使用 DualBeam 中分辨率zei高、功能zei强大的 FIB (Phoenix FIB),可将样品损伤降到zei小。结合 Phoenix 的小尺寸光斑和高度灵敏的 ICE 探测器(二次电子/二次离子探测器),操作员能够使用镓束轻松执行低电压zei终清洁。这消除了由于较高电压 FIB 光刻而导致的晶体损失,从而为 TEM 制作出高质量、几乎“无伪影”的样品。
特定于客户的方法以 FEI 创建、经预先测试的方法为基础,可确保在多个操作员之间实现一致的 TEM 薄片样品质量和通量。Helios G4 FX 将支持基于 FEI iFast™ 自动化软件的未来自动化日常预防性维护程序,以确保每天达到zei佳的系统性能。无论操作员技能水平如何,使用所有这些功能都能以一致方式跨多个工具制作超薄片样品。



|
除厂家/中国总经销商外,我们找不到
Helios G4 FX 等离子聚焦离子束 (FIB) 系统 的一般经销商信息,有可能该产品在中国没有其它经销商。
如果您是,请告诉我们,我们的邮件地址是:sales@antpedia.net 请说明: 1.产品名称 2.公司介绍 3.联系方式 |
售后服务
我会维修/培训/做方法
如果您是一名工程师或者专业维修科学 仪器的服务商,都可参与登记,我们的平台 会为您的服务精确的定位并展示。





