PCBA组装流程设计和表面组装元器件的封装形式(四)
六、BGA类封装
BGA类封装(Ball Grid Array),按其结构划分,主要有塑封BGA(P-BGA)、倒装BGA(F-BGA)、载带BGA(T-BGA)和陶瓷BGA(C-BGA)四大类,如图10所示。
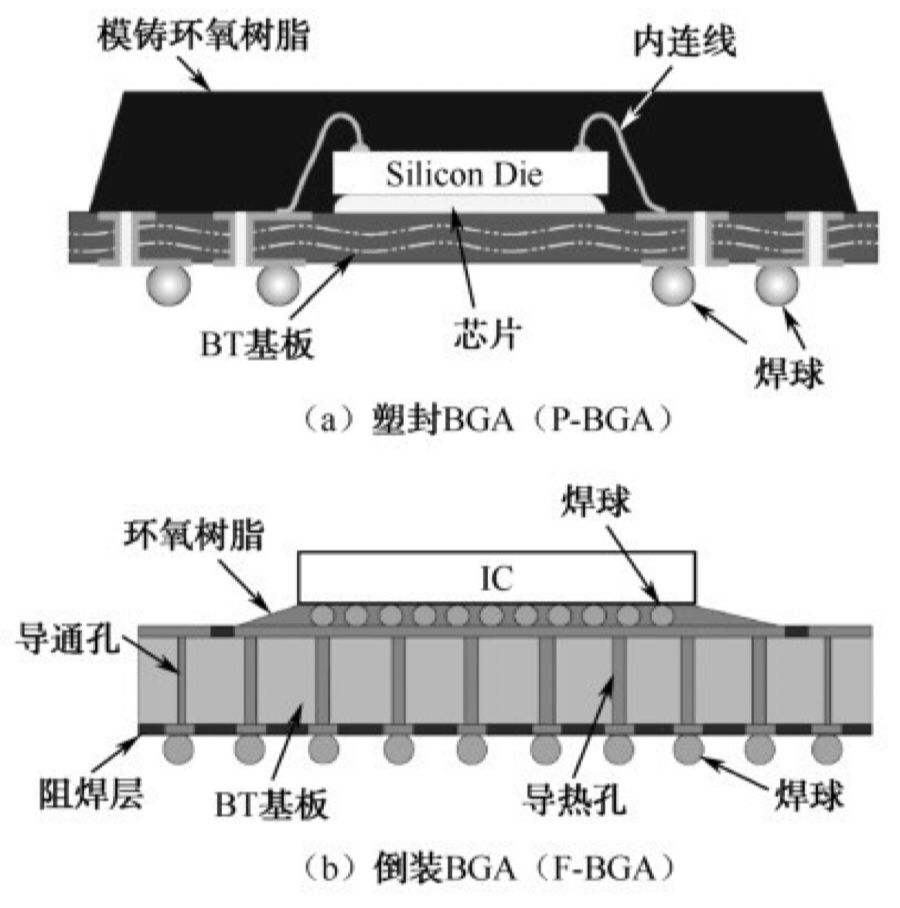
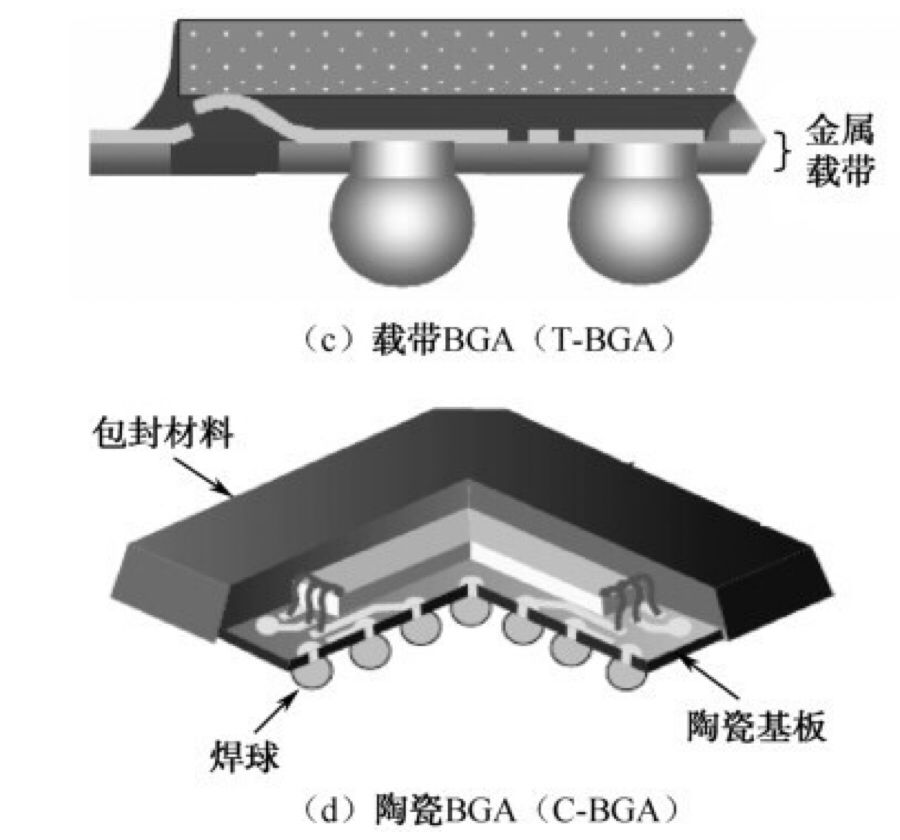
图10 BGA类的封装形式
(1)BGA引脚(焊球)位于封装体下,肉眼无法直接观察到焊接情况,必须采用X光设备才能检查。(2)BGA属于湿敏器件,如果吸潮,容易发生“爆米花”、变形等焊接缺陷或不良,因此,组装前必须确认是否符合工艺要求。(3)BGA也属于应力敏感器件,四角焊点应力集中,在机械应力作用下很容易被拉断,因此,在PCB设计时应尽可能将其布放在远离拼板边和安装螺钉的地方。
七、BTC类封装
在IPC-7093中列出的BTC类封装形式有QFN(Quad Flat No-Lead package)、SON(Small Outline No-Lead)、DFN(Dual Flat No-Lead)、LGA(land Grid Array)、MLFP(Micro Leadframe Package),如图11所示。
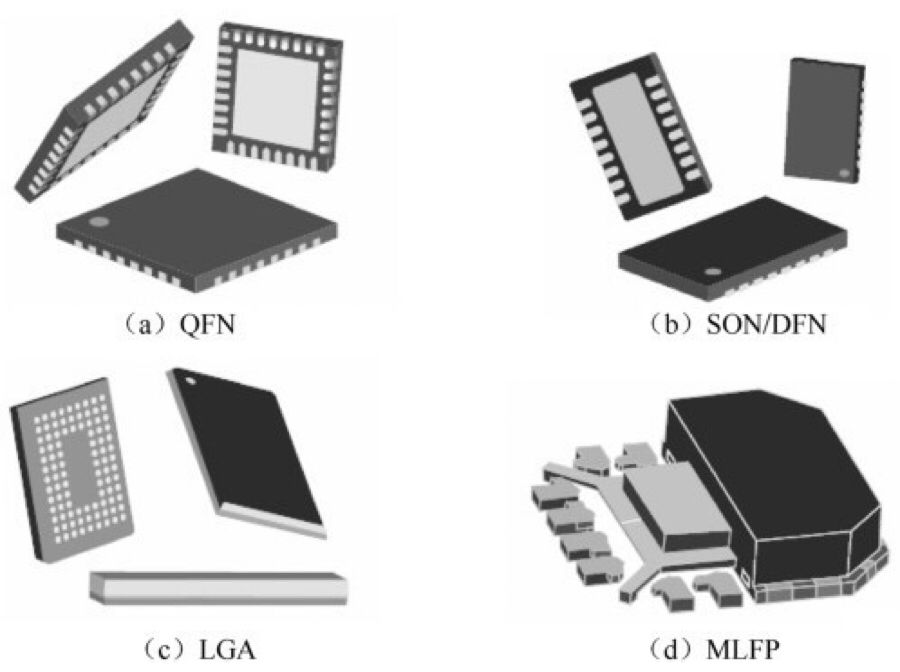
图11 BTC类的封装形式
(1)BTC的焊端为面,与PCB焊盘形成的焊点为“面-面”连接。(2)BTC类封装的工艺性比较差,换句话讲,就是焊接难度比较大,经常发生的问题为焊缝中有空洞、周边焊点虚焊或桥连。
这些问题产生的原因主要有两个:
一是封装体与PCB之间间隙过小,贴片时焊膏容易挤连,焊接时焊剂中的溶剂挥发通道不畅通;
二是热沉焊盘与I/O焊盘面积相差悬殊,I/O焊盘上焊膏沉积率低时,容易发生“元件托举”现象即热沿焊盘上熔融焊料将元件浮起的现象。经验表明,确保I/O焊盘上焊膏合适转移比减少热沉焊盘上的焊膏量更有效。