技术特点
【技术特点】-- 聚焦离子束(FIB)微型采样系统用于STEM分析
优异的高效分析性能
微型采样方法(已在日本和美国取得zl)已在半导体器件分析领域成为一款工具,它正迅速向更小制样方向发展。仅用一小时左右即可获得一个微小样品,以便于STEM分析,其定位精度可达到0.1 µm以下。
特点
聚焦离子束(FIB)微采样装置和聚焦离子束(FIB)微采样方法
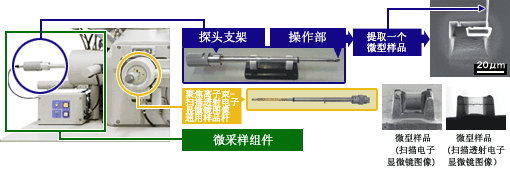
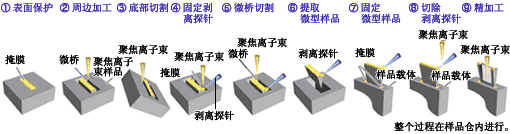
聚焦离子束(FIB)微柱状制样实例
一个微柱状样品,包含一个直接从半导体器件上准确地切割下来的分析点。改变入射聚焦离子束(FIB)的方向,把微样品切割或加工成任意形状。
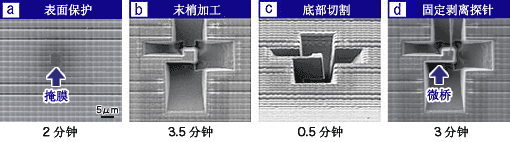

系统配置实例
聚焦离子束-扫描透射电子显微镜系统
新开发的半导体装置评估系统由FB2200聚焦离子束(FIB)系统和HD-2700 200 kV(STEM)扫描透射电子显微镜构成。从对材料缺陷(组织)的搜索到亚纳米薄膜高精度结构分析,只要几小时即可完成。
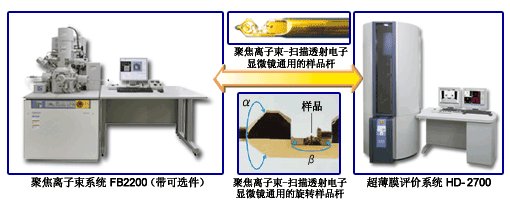
聚焦离子束-透射电子显微镜(扫描透射电子显微镜)(FIB-TEM(STEM))的样品杆可互换共用
观察实例
DRAM 观察实例
针尖顶端的微柱状样品SEM像
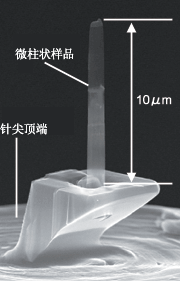
微柱状样品的明场STEM像
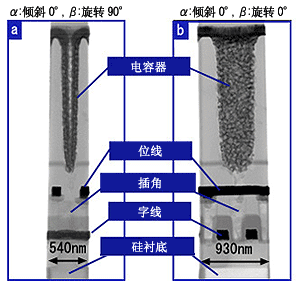
【技术特点对用户带来的好处】-- 聚焦离子束(FIB)微型采样系统用于STEM分析
【典型应用举例】-- 聚焦离子束(FIB)微型采样系统用于STEM分析
请扫描二维码查看详细参数


经销商
|
除厂家/中国总经销商外,我们找不到
聚焦离子束(FIB)微型采样系统用于STEM分析 的一般经销商信息,有可能该产品在中国没有其它经销商。
如果您是,请告诉我们,我们的邮件地址是:sales@antpedia.net 请说明: 1.产品名称 2.公司介绍 3.联系方式 |
扫描电镜SEM
售后服务
我会维修/培训/做方法
如果您是一名工程师或者专业维修科学 仪器的服务商,都可参与登记,我们的平台 会为您的服务精确的定位并展示。





