芯片集成度越来越高,故障后失效分析该如何“追凶”-1
随着科技进步,智能化产品与日俱增。从电脑、智能手机,再到汽车电子、人工智能,如今在我们的生产生活中已随处可见。它们之所以能够得以发展,驱动内部收发信号的半导体芯片是关键。

我们这里讲的半导体为IC(集成电路)或者LSI(大规模集成电路)。制造的芯片可以分为逻辑芯片、存储芯片、模拟芯片、功率器件。根据摩尔定律,每18-24个月,集成电路上可以容纳的器件数目就会增加一倍,这将让更多的科技应用逐步实现,并得以优化。应用场景和市场的扩大,半导体芯片的需求无疑也会随之增长,对其质量则有了更高的要求。
比如汽车行业,除了传统的汽车电子,目前也有许多目光投向了自动驾驶。像这样高度涉及人身安全的车用芯片,在高温、低温、受潮、老化、长期工作等因素下,性能都必须保持稳定。所以,无论从半导体芯片的研发设计,再到前道工序,后道工序,甚至最终投入使用,每一个流程都需要有必要的检测来护航。

芯片制作流程概括性示意
对于芯片制造商来说,单纯知道芯片是否达标,以此来淘汰坏品保证输出产品质量,是远不够的。还需要“知其所以然”,保证良率,追根溯源,节约成本的同时给企业创造更高的效益。所以围绕着这个主题,将进行一系列的检测,我们将此称为半导体失效分析。它的意义在于确定半导体芯片的失效模式和失效机理,以此进行追责,提出纠正措施,防止问题重复出现。
失效分析检测简直就像一场“追凶”之旅。通过初步证据锁定嫌疑范围,再通过各种方法获得更多证据,步步锁定,拨开层层“疑云”去获得最终的真相。检测流程上,一般来说,制造商会首先对待测半导体晶圆(wafer)或裸片(die)实施传统的电性测量。一方面来确定芯片是否有故障的情况存在;一方面,若故障确切存在,也可以为后续失效分析提供必要的信息。

已经过诸多工艺处理后的晶圆(wafer),裸片(die)即从其切割而来
但想达到溯源的目的,仅凭传统的电性测试是远不够的。还需要进一步了解缺陷具体存在的位置,甚至还原出失效的场景、模式,用以了解失效机理。这也就是在半导体失效分析中重要而困难的一项,缺陷定位。失效分析工程师结合测试机测得的失效模式以及其他故障信息,可以初步判断需要采取的定位方法,然后不断结合获得的新数据,逐步推测出失效发生在芯片的哪层结构中,及其根本缘由。

缺陷定位
而半导体工艺日新月异发展飞速,制程上,从70年代的微米级芯片早已经提升至纳米级芯片。芯片层数增加和晶体管数量的急剧增加,让失效点越来越难以发现。不断提升的集成度,对检测设备的性能提出了更多的挑战。


1971年到2000年,英特尔芯片的发展
-
企业风采
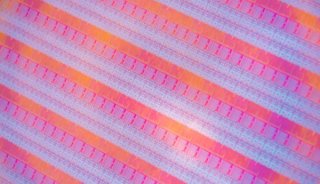
-
企业风采

-
焦点事件

-
焦点事件

-
市场商机

-
科技前沿

-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
科技前沿

-
焦点事件

-
焦点事件

-
焦点事件

-
科技前沿
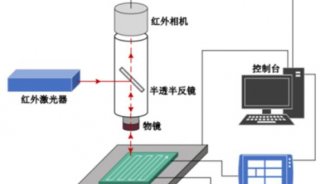
-
焦点事件

-
科技前沿

-
并购

-
科技前沿

-
焦点事件

-
科技前沿

-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
项目成果
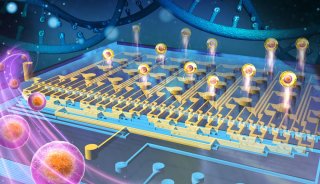
-
项目成果

-
科技前沿

-
焦点事件