解读BGA、CSP再流焊接接合部工艺可靠性设计(二)
在此场合下BGA、CSP中央部分将存在间隙G,为填充该间隙G所必需的钎料量(如图6所示),其体积V可按下式求得。为填补这个间隙G所必需的钎料量,即最大钎料量Qmax,可按下式求得Qmax=πD^2G/4(mm3) (2)
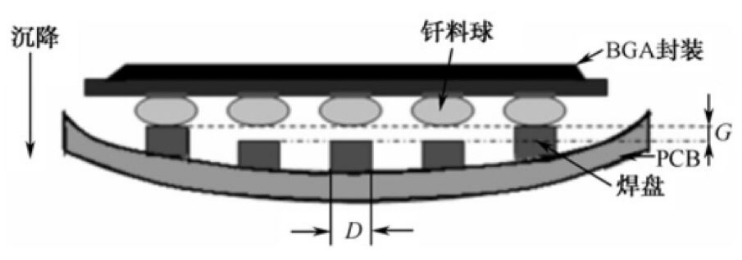
图6 必需钎料量的确定
二、焊盘设计
图7所示为BGA、CSP封装结构参数,表1所示为供应商提供的相关具体标称尺寸,在此基础上进行PCB焊盘设计。
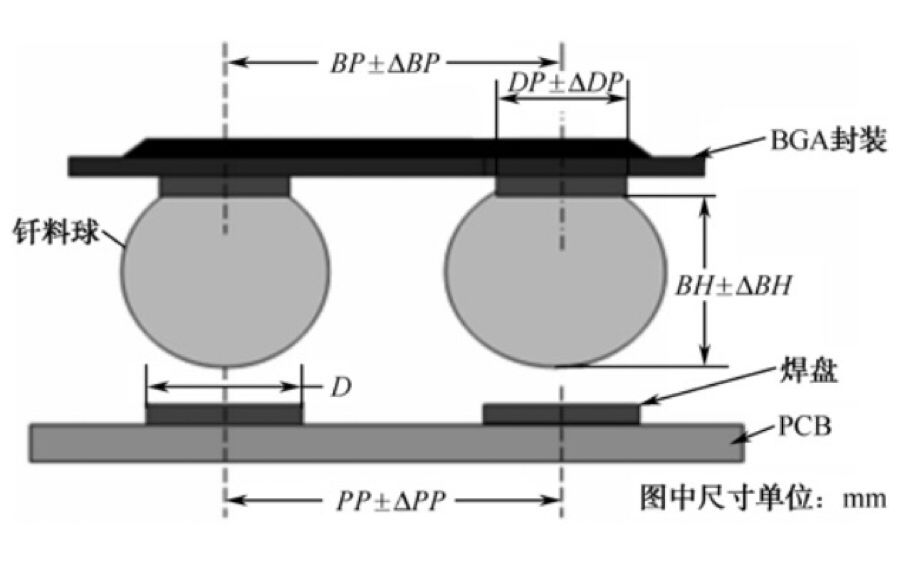
图7 焊接接合部焊盘尺寸的确定
表1 BGA、CSP封装钎料球尺寸
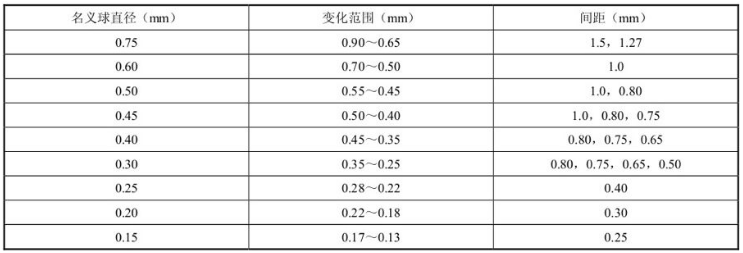
由于BGA、CSP的焊盘形状大部分均采用圆形,故接合部焊盘设计的主要内容是:1)确定圆形焊盘的最大直径(Dmax)前面已讨论了从可靠性看焊盘接合部的最薄弱的部分,也就是断面最小的地方。因此,PCB基板上的安装焊盘最大直径(Dmax)的取值通常就与BGA、CSP封装焊盘直径相同,即Dmax=BGA、CSP封装的焊盘直径 (3)2)确定圆形焊盘的最小直径(Dmin)圆形焊盘的最小直径(Dmin)通常可通过BGA、CSP的贴装精度和BGA、CSP本身的尺寸精度,再综合由熔融钎料的表面张力所形成的自调整作用的影响来求得,即

式中 δ5——贴片精度;ΔBP——钎料球间距精度;ΔPP——PCB焊盘间距加工精度。三、印刷钢网开口尺寸的确定1.钢网开口直径设计就钢网开口部设计与焊盘相比,当印刷机位置精度较高时,其设计方法基本上与片式元器件相同。此时,为不使钎料量过多,将位置精度估计为0.05mm,故钢网开口直径=焊盘直径-0.05 (3)2)印刷厚度的管理值一般在焊膏的总体积中,钎料合金含量与助焊剂等的体积大约各占总体积的一半。
由此,可得出具体焊膏印刷体积控制范围为Vmax=2Qmax (4)Vmin=2Qmin (5)由式(3)~式(5)可求得对应的最大印刷厚度Tmax和最小印刷厚度Tmin。Tmax=Vmax/(钢网开口面积) (6)Tmin=Vmin/(钢网开口面积) (7)3)工艺可靠性设计注意事项由于BGA、CSP组装后的焊点检测是困难的,因此,必须按照工艺设计的基本思路,把获得完好的质量放在第一位,这时一个非常重要的因素是保证钎料的润湿性。如前所述,BGA、CSP再流焊接时钎料的表面张力产生的沉降现象和自调整效果,有利于焊点质量的改善。
-
会议会展

-
政策法规

-
标准

-
科技前沿

-
企业风采

-
企业风采

-
焦点事件

-
政策法规

-
产品技术

-
会议会展

-
精英视角

-
焦点事件

-
项目成果

-
标准

-
焦点事件

-
焦点事件

-
标准

-
企业风采

-
产品技术

-
焦点事件

-
标准

-
焦点事件

-
焦点事件

-
综述
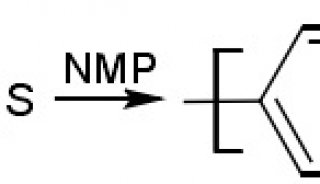
-
焦点事件

-
焦点事件

-
焦点事件

-
焦点事件

-
产品技术

-
焦点事件

-
产品技术

-
焦点事件

-
综述

-
综述

-
焦点事件

-
企业风采

-
焦点事件

-
焦点事件

-
技术原理

-
焦点事件

-
标准